KLA-Tencor推出新一代电子束缺陷再检查和分类系统
——
KLA-Tencor 电子束产品群副总裁 Zain Saidin 表示:“随着设计准则缩小到 45 纳米及以下,缺陷检查和良率工程师越来越关心其电子再检查工具所建立的缺陷 Pareto 图的品质。我们最新一代的光学检测系统 281x 和 Puma 9150 能够寻找到小于 50 纳米的关键性缺陷,而以往的电子束再检查系统很难对这些缺陷进行再检查。大量的“找不到”或“电子束不可见 (SNV)”缺陷充斥缺陷 Pareto 图,进而影响工程师做出提高良率和工艺监控的正确决策。将 eDR-5200 纳入我们的缺陷解决方案后,能在更短的时间内大量减少 SNV 的数量,并使缺陷 Pareto 图更准确地反映晶片上关键缺陷 (DOI) 的种类和数量。”
eDR-5200 采用的浸没式设计(请参阅技术概要),突破了一直阻碍传统电子束再检查系统欲进一步增加分辨率的障碍,进而可对 50 纳米以下的缺陷进行成像和分类。借助行业领先的定位平台精确度,以及在 KLA-Tencor 光学检测系统上产生的patch图像,eDR-5200可降低缺陷 Pareto 图中的SNV比例达一个数量级以上。同时,其一系列全新的缺陷分类方法将进一步帮助用户快速建立有意义的,高品质的缺陷 Pareto 图。例如,智慧协助分类 (ePAC) 可让用户不必经历漫长而繁琐的设置过程就从手动分类过渡到完全自动分类。
KLA-Tencor 在 eDR-5200 电子束再检查系统和其光学检测系统之间建立起独特连接,让用户能在 eDR-5200 上就可设置和优化光学检测系统的程式,而无需在系统间来回传送晶片。其结果是检测系统程式设置的时间可缩短一半,同时质量得到显著提高,使缺陷 Pareto 图上能显示更大比例的需关注缺陷,和更少的 SNV 缺陷。此外,当 eDR-5200 再检查系统和 KLA-Tencor 光学检测系统配合使用于工艺窗口鉴定 (PWQ) 时,获得结果的时间可缩短 10 倍以上。eDR-5200 再检查和分类系统和 KLA-Tencor 光学检测系统的完美结合能创造出目前市面上生产效率最高的检测-再检查-分类解决方案。
eDR-5200 再检查和分类系统现已在亚洲、欧洲和美国等地区的存储和逻辑器件生产厂安装和使用。许多厂家依靠该系统独有的行业领先的高分辨率图像和再检查能力,以及与 KLA-Tencor 光学检测系统的有效连接,已经成功地在最短的时间内建立起最高品质的缺陷 Pareto 图。














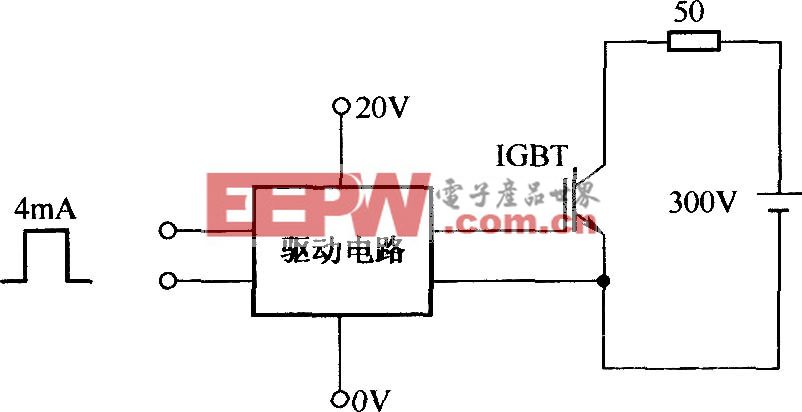

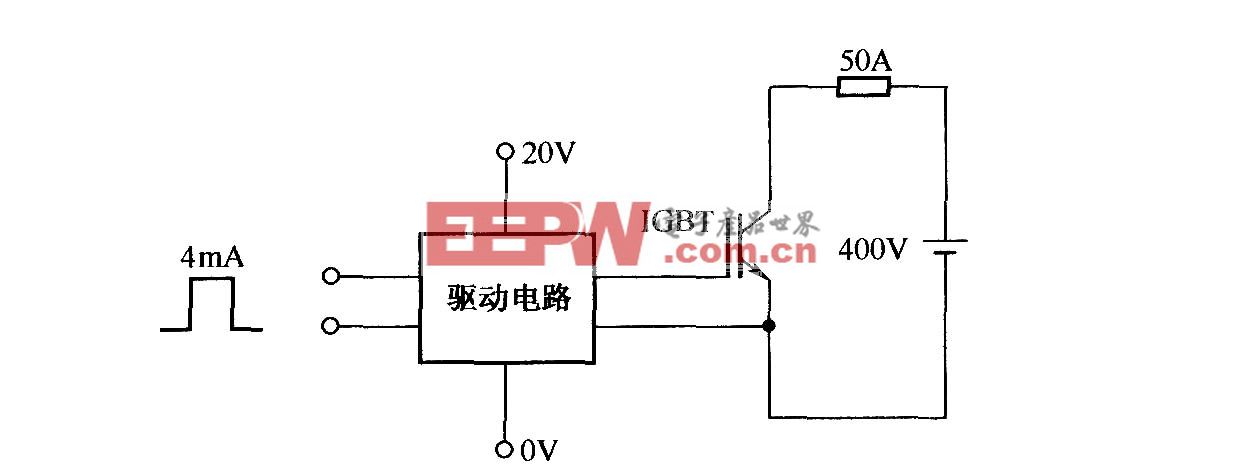


评论