Aviza与瑟思将重点集中于ALD膜层的晶圆背面和倒角处的去除解决方案
2005年7月11日讯—经过量产验证的热处理系统以及原子膜层沉积(ALD)的全球供应商Aviza Technology公司, 和半导体业界中单晶圆湿式处理技术的市场领先者及首要的技术创新者SEZ(瑟思)集团于今日联合宣布,将携手应对新一代IC制造过程中面临的关于去除ALD膜层的一系列重要挑战。协议约定,两个公司将利用双方的专家技术,共同开发应用于ALD高级膜层的沉积和去除等解决方案,合作重点将是晶圆的背面和倒角。
SEZ全球新兴技术部总监Leo Archer 博士评论说:“随着半导体器件的日益复杂化,在IC制造工艺过程中,晶圆背面和倒角膜层的去除技术也变得越来越重要。”他进一步表示:“由于双方都能够很好地定位以解决90纳米技术节点以下的膜层沉积和去除的复杂问题,因此与Aviza Technology公司的合作将是一个双赢的创举。通过开发、定义以及细化ALD膜层去除的工艺制程,我们确信能够为客户提供他们所需要的解决方案,以应对先进的半导体制造的挑战。”
退火的条件往往能够影响到晶圆背面和倒角膜层去除工艺过程的复杂程度。随着晶体化水平的不断增加,经过退火的膜层需要定制化的生产程式和化学品,以确保精确的去除,同时还要能够保证膜层属性的完整性,并降低交叉污染-进而提高良率。由于合成物的复杂性,这种高级膜层的目标往往定位于45纳米的高k值的门极绝缘体-诸如氧化铪(HfO)、硅酸铝(HfSiO), 氮氧硅酸铪(HfSiO/N)以及金属类的钌(Ru)-在膜层去除的阶段,引发了更大的挑战,即要有选择地去除从晶圆背面和倒角处的这些材料导致的污染,同时对晶圆正面进行有控制地保护,以防止交叉污染和微尘粒子的产生。这些可能会导致一些会影响器件性能、薄膜分层和光刻的问题,最终会影响器件的良率。因为,当基层材料是硅、氧化硅、或者是氮化硅时,过多的除去在下面的基层材料未必有利,甚而可能造成不必要的伤害。过量的蚀刻可能会去除一层必要的扩散栅极,也可能会影响晶圆的表面平整度和均一度。因此,膜层去除的选择比很重要。
显而易见,SEZ的旋转处理器技术有利于这类工艺制程,原因是该技术允许将已长有图形(patterned)的晶圆正面朝下,在已获得专利的柏努利(Bernoulli)卡盘上进行处理。而且更为重要的是组合的卡盘、化学品配送系统以及反应仓使得晶圆正面到预先定义的距离上的高度控制的保护。
Aviza Technology 公司ALD产品管理总监Jon Owyang表示:“材料和工艺制程ALD应用的研发是加快ALD的发展路线和推动ALD的被市场的采纳的关键。Aviza正在持续地评估和开发高级膜层以便及时完善新一代的制造工艺制程。通过与SEZ合作,我们意欲有效利用公司核心领域的专家技术为我们的客户开发出先进的制造和工艺制程解决方案,以达到晶圆背面的对微量材料和晶圆背面的对微尘粒子程度的要求。”
Aviza 和SEZ 集团将于2005年7月12-14日在美国旧金山(San Francisco)的Moscone Convention Center 举行的SEMICON West 2005展会上参展。如若需要了解关于这两家公司和它们的产品的更多信息,届时敬请光临南厅#1616的Aviza展台和北厅#5568的 SEZ集团展台。








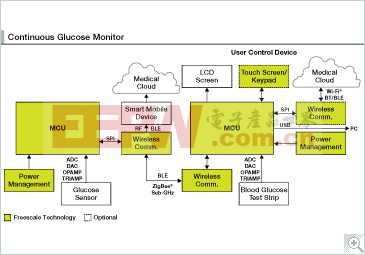



评论