先进封装市场产能告急,台积电CoWoS扩产
AI订单激增,影响传至先进封装市场。
今年一季度以来,市场对AI服务器的需求不断增长,加上英伟达的强劲财报超出预期,造成台积电的CoWoS封装成为热门话题。据悉,英伟达、博通、谷歌、亚马逊、NEC、AMD、赛灵思、Habana等公司已广泛采用CoWoS技术。
随AI需求全面引爆,台积电启动CoWoS大扩产计划,业内传出,台积电6月底再度向台系设备厂大举追单,同时也要求供应商全力缩短交期支持,预期今年第四季至2024年首季将进入大量出机高峰。
台积电董事长刘德音在今年股东会上表示,最近因为AI需求增加,有很多订单来到台积电,且都需要先进封装,这个需求远大于现在的产能,迫使公司要急遽增加先进封装产能。业界消息指出,台积电于6月底启动第二波追单,推估今年底CoWoS月产能将达到1.2万片,2024年将翻倍成长。
事实上,在CoWoS产能排挤效应下,确实有越来越多大厂提升采用封测厂先进封装方案的意愿,例如英伟达培养Amkor为第二供应商,同时因设备交期拉长到6~9个月、产能供不应求,近来不只台积电急于向设备厂追单,封测厂的询问度也暴增,企图要在AI浪潮下提前备妥军备、争抢先机。
市场人士认为,封测厂跟晶圆厂在先进封装市场的定位与优势不同,彼此的合作关系大于竞争,目前包括日月光、Amkor、长电科技等封测大厂早已具备先进封装技术,且因具备技术升级及价格优势,可望成为大厂另一个选择方案。未来随着AI市场大饼快速增胖、先进封装需求喷发,除可抢到更多客户订单,也有机会进一步扩充产能,对设备业者相当有利。
2028年有望达到160亿美元CoWoS封装的订单增加只是先进封装市场火热的一角。Yole 预测,先进封装市场将每年增长 40%,到 2028 年达到 160 亿美元。
据Yole Intelligence预测,2022年先进封装市场规模预计将达到22.1亿美元,并将继续以40%的复合年增长率(CAGR)增长,到2028年将达到160亿美元预计会扩大到更大规模。
 图 1:2022 年和 2028 年先进封装市场规模(来源:Yole Intelligence)
图 1:2022 年和 2028 年先进封装市场规模(来源:Yole Intelligence)所有高性能封装平台的一个关键技术趋势是缩小互连间距,包括 TSV、TMV(穿模通孔)、微凸块和混合键合,这是目前最先进的解决方案。这些技术的进步对于适应更复杂的单片芯片和小芯片的集成非常重要,通过它们可以实现更快的数据处理和传输,同时消耗更少的功耗。它还将促进下一代更高密度的集成和带宽。

图2:2022年至2030年硅中介层关键参数路线图(2028年后未发布)
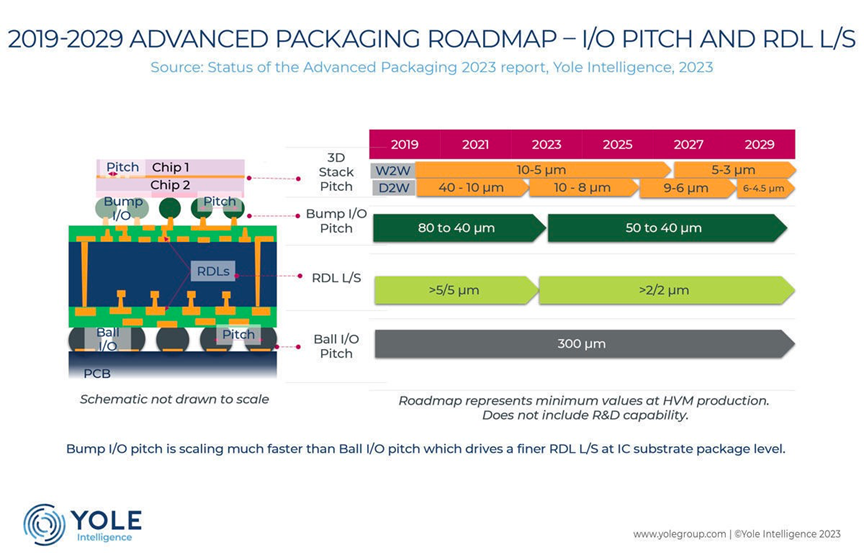
图 3:2019 年至 2029 年先进封装路线图。显示 I/O 间距、RDL(重新分配层)线和空间转换预测
英特尔、台积电和三星等领先的半导体公司利用了先进封装市场的增长优势,在高性能封装方面实现了比 OSAT 更快的上市时间。这一策略对OSAT构成间接威胁,纵观2022年先进封装供应商前15名销售额排名,第一名是全球最大的OSAT,日月光(包括SPIL),第二名是美国Amkor,第三名是Intel,第四名是台积电,第五位是中国长电科技,第六位是三星。

图4:2022年先进封装供应商营收前15名排名
先进封装被视为后摩尔时代的关键技术,但中美冲突正在扰乱供应链,并影响半导体公司获得芯片和制造设备。由于供应链的变化和贸易摩擦导致的生产转移,供应链正在多元化,但中国的产能也有可能增加。
随着设备制造商扩大其在先进封装领域的影响力,65% 的先进封装晶圆由 OSAT 提供服务,他们希望通过扩展其测试专业知识来扩大其影响力。各种玩家已经进入这个领域,并试图接管 OSAT 的业务。此外,虽然基板供应商的目标是扩大产能,但不可能立即做到,Yole指出,未来两到三年可能会出现持续供应问题。
国内封装企业持续加大先进封装研发投入
除了CoWoS,Chiplet异构技术是另一个热门的先进封装技术。Chiplet凭借设计灵活、上市周期短、成本低等优势,成为全球延续“摩尔定律”的重要路径之一。
Chiplet异构技术不仅可以突破 GPU 等算力芯片先进制程的封锁,并且可以大幅提升大型芯片的良率、降低设计的复杂程度和设计成本、降低芯片制造成本。目前,Chiplet 已广泛应用于服务器芯片。
国内封装企业持续加大先进封装研发投入,紧密合作国内外知名客户,有望率先受益先进封装带来的收入利润贡献。围绕先进封装这些环节的设备、材料供应链有望受益先进封装市场增长带来的增量需求。
通富微电在2.5D和3D等先进封装技术布局,已为AMD大规模量产Chiplet产品,公司CPU、GPU专用封测能力行业领先。
芯源微针对在Chiplet技术路线下Fan-out、CoWoS等封装工艺路线,已成功研发临时键合机、解键合机产品。
长电科技的XDFOIChiplet高密度多维异构集成系列工艺已进入稳定量产阶段,实现国际客户4nm节点多芯片系统集成封装产品出货。
来源:半导体产业纵横
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。



