ANSYS获台积电SoIC先进3D晶片堆叠技术认证
ANSYS针对台积电 (TSMC) 创新系统整合晶片 (TSMC-SoIC) 先进3D晶片堆叠技术开发的解决方案已获台积电认证。SoIC是一种运用Through Silicon Via (TSV) 和chip-on-wafer接合制程,针对多晶粒堆叠系统层级整合的先进互连技术,对高度复杂、要求严苛的云端和资料中心应用而言,能提供更高的电源效率和效能。
本文引用地址:http://www.amcfsurvey.com/article/201904/399932.htmANSYS的SoIC多物理场 (multiphysics)解决方案支援萃取(extraction)多晶粒共同模拟 (co-simulation) 和共同分析 (co-analysis)、电源和讯号完整性分析、电源和讯号电子迁移(electromigration;EM)分析以及热和热应力分析。
除SoIC认证外,台积电也验证了运用ANSYS RedHawk、ANSYS RedHawk-CTA、ANSYS CMA、和ANSYS CSM的最新Chip-on-Wafer-on-Substrate (CoWoS) 封装技术叁考流程,以及对应的系统层级分析晶片模型。
台积电设计基础架构行销事业部资深协理Suk Lee表示:「我们对与ANSYS合作推出TSMC-SoIC的成果感到非常满意。这让客户可以满足云端和资料中心应用持续增长的效能、可靠度和电源需求。本次合作结合了ANSYS的完整晶片-封装共同分析(chip-package co-analysis)解决方案及台积电的SoIC先进制程堆叠技术,来因应复杂的3D-IC封装技术多物理场挑战。」
ANSYS总经理John Lee表示:「我们的3D-IC解决方案因应了复杂的多物理场挑战,满足严苛的电源、效能、散热和可靠度需求。ANSYS提供完整晶片感知 (chip aware) 系统和系统感知 (system aware) 晶片signoff解决方案,帮助共同客户更有信心地加速设计整。」



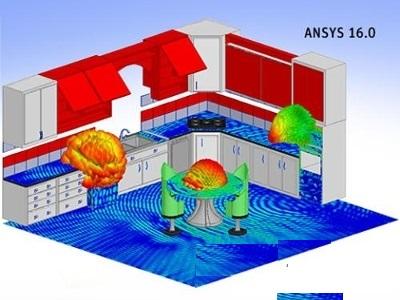



评论