挑战 ASML,应用材料公司重新定义了光刻和图案化市场
ASML 的 EUV 光刻工具真的很贵。每个 EUV 工具的价格现在接近 1.7 亿美元,其中的许多用于领先的半导体工厂。未来,每个 High-NA EUV 工具的成本将超过 3.5 亿美元。此外,这些晶圆厂还需要许多 DUV 光刻工具。每个人都想要一种更具成本效益的方式来图案化芯片,因为仅光刻就消耗了 3nm 工艺节点成本的约 35%。想象一下,如果有办法打破这种趋势……
本文引用地址:http://www.amcfsurvey.com/article/202303/444327.htm近日,世界第二大半导体设备制造商应用材料公司宣布他们有一个潜在的解决方案。该解决方案就是 Centura Sculpta 工具,这是一种可以执行新工艺步骤「图案塑造」的新工具。根据 Applied Materials(应用材料公司) 的说法,Sculpta 工具可用于将某些层的 EUV 光刻的使用减少一半之多。如果属实,这将重塑行业的成本结构。Applied Materials 的说法有很大的不确定空间,所以让我们来讨论一下细节。
本文将深入探讨新的 Centura Sculpta。我们将讨论该技术的工作原理、对 EUV 多重图案化和 High NA EUV 的影响、它的应用领域(前端、触点、通孔、各种金属层、剂量减少),以及这些用例如何随着未来的工艺技术扩展。此外还包含使用 EUV 或混合使用 EUV 和 Scuplta 的实际工艺节点的成本比较。我们将分享该工具的吞吐量、周期时间、成本、我们的出货量预估以及来自第一个客户的收入预估。
如何实现 EUV 需求潜在 45 亿美元的减少,影响将在哪一年达到这个规模,以及什么可以使这个数字上调/下调。还有台积电、三星和英特尔对具有 2nm 级节点的 Centura Sculpta 的采用和插入点。这将包括特定工艺节点的详细信息,包括用于即将使用应用材料公司 Sculpta 的工艺技术的最小间距和 Sculpta 层。本文将讨论该决定的利弊。
引入新的图形成形步骤对其他工艺步骤的影响,包括光刻、光刻胶、涂布机/显影剂、CVD、PVD、蚀刻、CMP、外延生长、离子注入、计量和检测。图案塑形对行业供应商有许多影响,包括但不限于 ASML、Lam Research、Tokyo Electron、JSR、TOK、Shin-Etsu、Lasertec、KLA、Onto、Nova、Hoya 和 Asahi Glass。
首先,半导体和金融行业的人们对这个工具有很多不屑一顾的地方。有人争辩说,这并不是什么新东西,它只是一种非常昂贵的电感耦合等离子体形式,用于进行反应离子蚀刻,这在大批量制造中已经存在了数十年。对此,人们也可能会争辩说,光刻技术已经存在了 150 年,而 EUV 也不是什么新鲜事物。
另一个主要的驳斥理由是它不成熟,而且还很遥远。那也是错误的。虽然 Sculpta 上周才在 SPIE 的光刻和高级图案会议上正式宣布,但这个新工具已经推出很长时间了。至少从 2015 年开始,应用材料公司就一直在发布关于这种工具类型的公开研究论文。自 2017 年以来,第一个客户一直在与应用材料公司合作开发该工具。应用材料公司甚至在去年的 SPIE Advanced Lithography & Patterning 会议上进行了技术演示,并提供了真实的客户测试数据。
应用材料公司的 Centura Sculpta 并不是完全不成熟且远离生产的疯狂技术。Sculpta 是真实的,它确实有效,它将在未来几年内产生数亿美元的收入。鉴于它被宣传为在第一个用例中直接去除 EUV 双重图案化,首先让我们快速回顾一下光刻多重图案化过程。
光刻多重图案化工艺
光刻是大批量半导体制造的核心工艺。一旦突破了光刻工具的限制,你仍然可以通过转向各种多重图案化方案来继续缩放单个特征尺寸。下面是「光刻-蚀刻-光刻-蚀刻 (LELE)」的简化描述,这是最常见的多重图案化方案之一。为了简单起见,我们将把其他方案(如 SADP 和 LELB)放入与 LELE 相同的分类中。
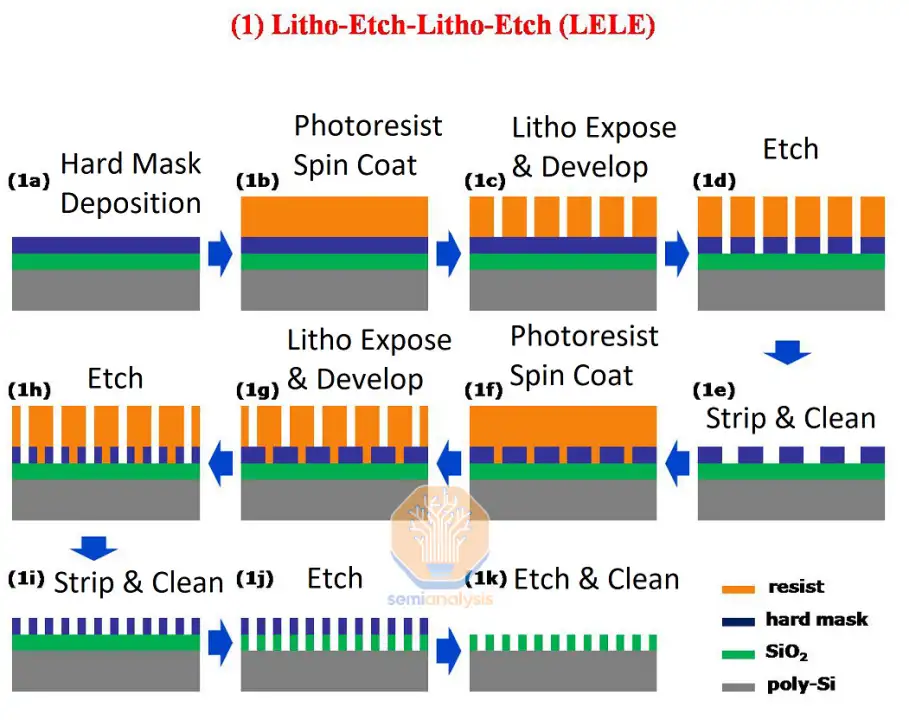
LELE 工艺流程经过两次完整的光刻周期,以实现比单个图案化步骤更紧密的特征尺寸。整个周期可以是几十个不同的工艺步骤,包括硬掩模的沉积、底层、中间层、SARC、CMP、清洁、剥离、旋涂、烘烤、显影、曝光、蚀刻以及其间的各种计量/检查步骤。
关键在于,从单一的光刻周期到 LELE 工艺涉及到双倍的光刻成本以及该工艺中涉及的许多其他工具。
应用材料公司专门将 EUV 多重图案化减少作为 Sculpta 的第一个用例。他们声称他们可以通过单个光刻周期和 Sculpta 实现与 LELE 相同的特征保真度。
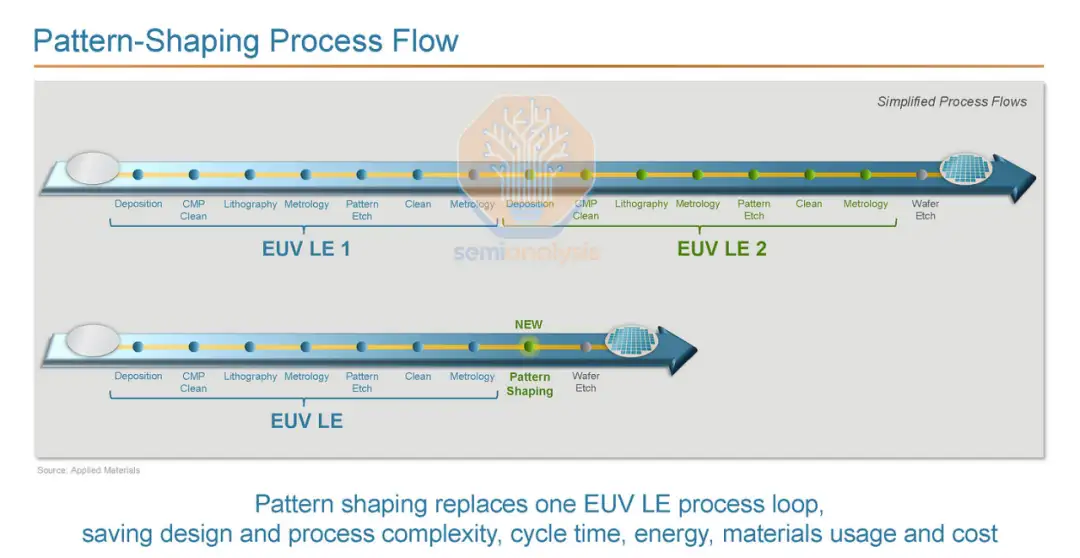
我们估计每个晶圆约 25 千瓦时,每个晶圆约 0.5 千克二氧化碳当量排放量以及每个 LE(光刻蚀刻)循环每个晶圆约 15 升水。在右边的框中,我们显示了成本。估计每月每 100,000 个晶圆启动的资本成本约为 3.5 亿美元,每个晶圆制造或每个 EUV 循环每个晶圆的运营成本约为 70 美元。成本节省,估计每月每启动 100,000 个晶圆可节省约 2.5 亿美元的资本成本,每个晶圆可节省约 50 美元的制造成本。
应用材料公司宣称的成本、电力、水和二氧化碳节约量是巨大的。台积电已将其 7 纳米和 5 纳米节点的产能提高到(大约)每月 200,000 片晶圆。这将为他们节省 5 亿美元的资本支出和超过 1 亿美元的年度运营费用。我们的数字不同,稍后我们会分享。
台积电 5nm 具有 EUV 多重图案化步骤。台积电 3nm 包含多个 EUV 多重图案化步骤。该技术的目标是插入「2nm」级节点,该节点可能包含 10 多个 EUV 多重图案化步骤,而无需应用材料公司 Sculpta 图案整形。如果假设 Sculpta 可以在任何地方使用,那么使用 Sculpta 每年可以节省数十亿美元。
该分析过于简单化,不能在任何地方使用模式塑造。我们将分享它的使用地点和方式,但首先让我们来谈谈什么是 Sculpta 和模式塑形。
什么是 Centura Sculpta 和 Pattern Shaping?
Centura Sculpta 的核心是能够执行一种称为模式塑造的新型步骤。图案整形是以一定角度向晶圆射出带状等离子束。与晶圆相比,角度可以控制在 0 到 70 度之间。零角与晶圆的角度成 90 度。
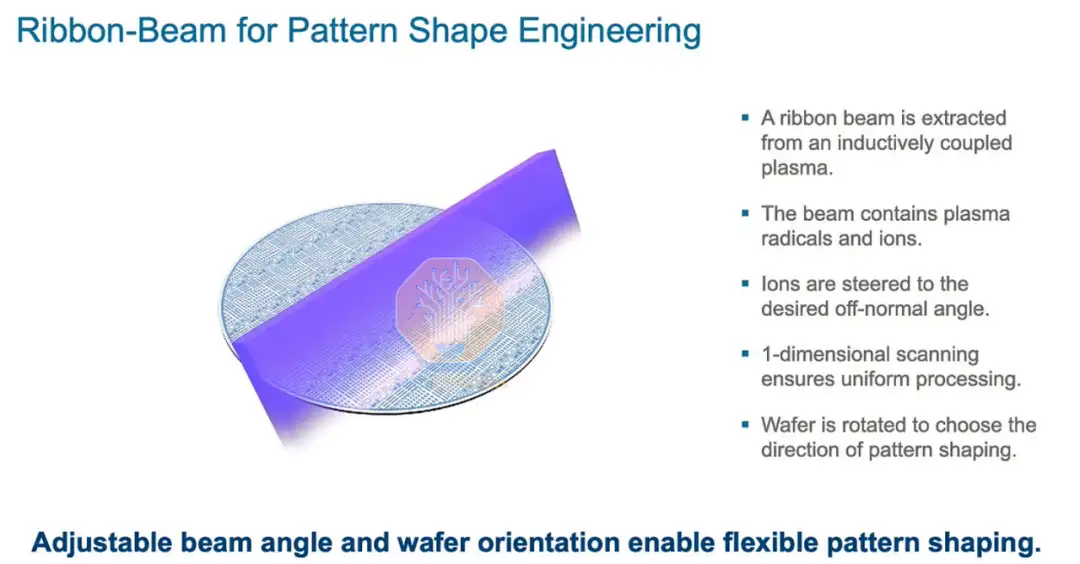
等离子束以一维方式行进,以保持晶圆上的处理均匀。目的是在 1 个方向上单向延伸特征。通过旋转晶圆并再次使光束穿过晶圆,可以在任何方向上执行图案整形。
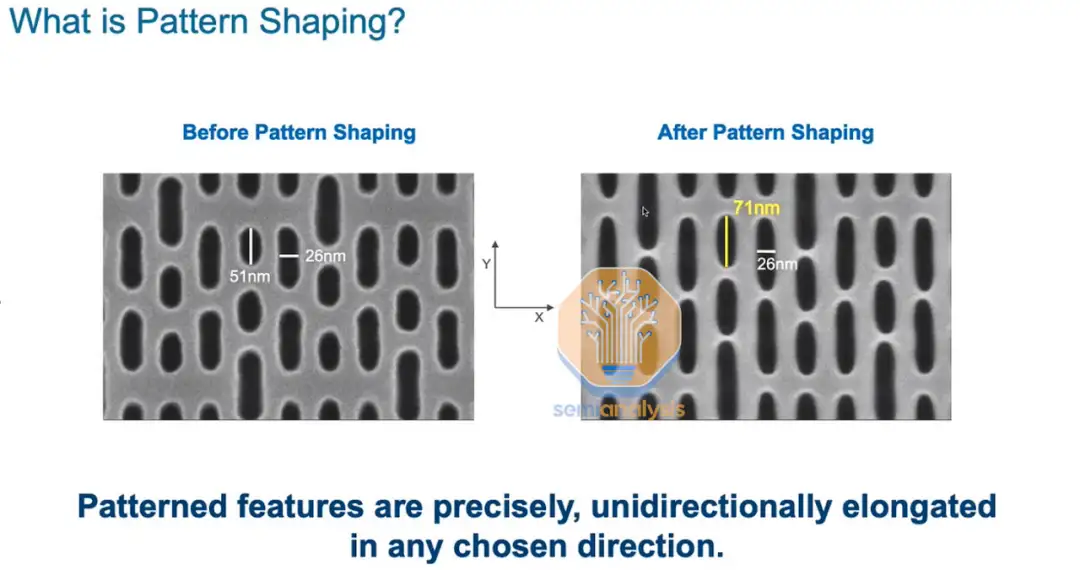
图案整形不能影响需要保持不变的硅特征的关键尺寸,这一点至关重要。这意味着仅更改一个轴上的特征是至关重要的。应用材料公司表示,对于另一个方向上每 1 个长度单位,他们可以将单个尺寸改变 20 个长度单位。
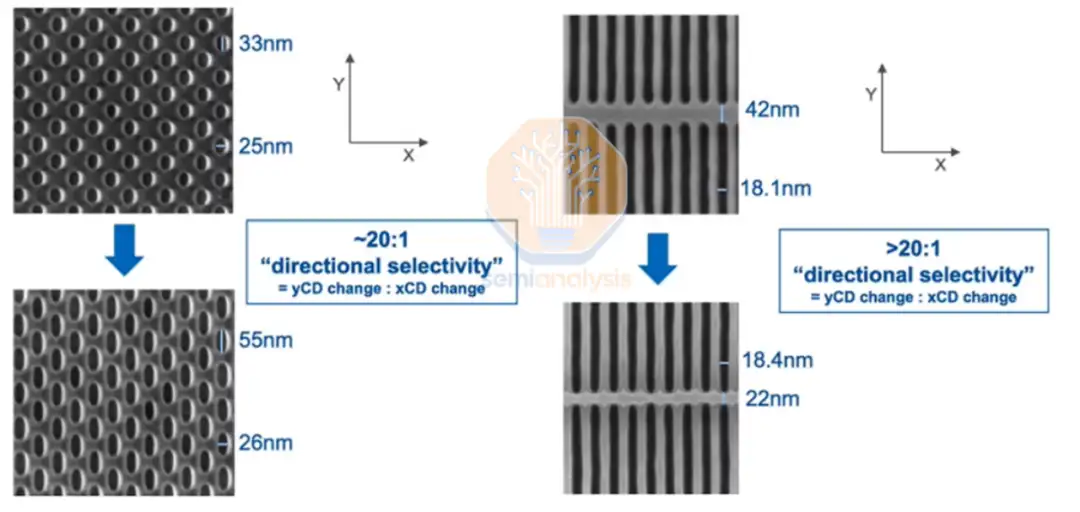
这在方向上是高度选择性的。晶圆厂还可以通过增加或减少带状光束轰击所花费的时间来控制图案被拉长的程度。蚀刻时间是晶圆厂可以利用的一个重要杠杆。
保持形状统一的另一个考虑因素是确保针对晶圆上的各种不同结构优化光束角。
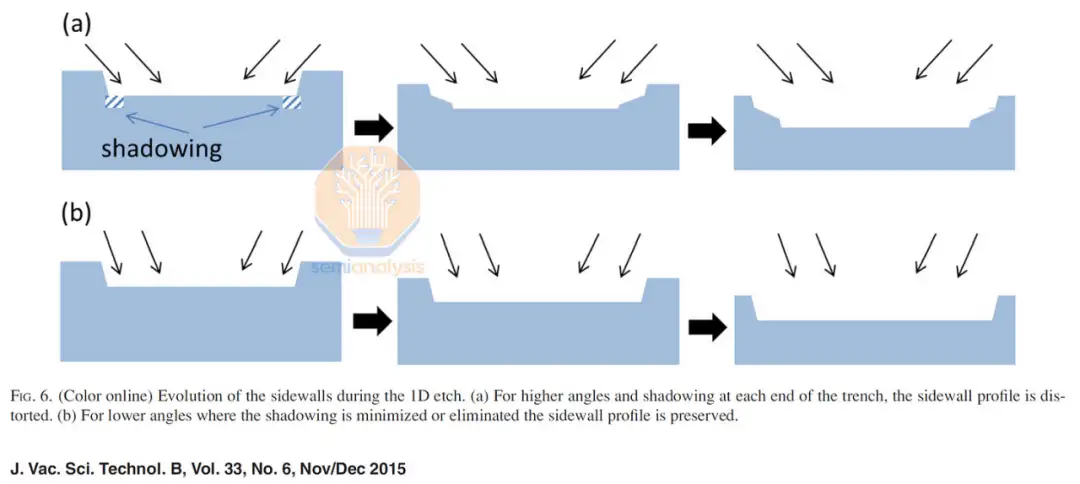
如果光束角度未正确对齐,则可能会在不同尺寸的结构上产生阴影。
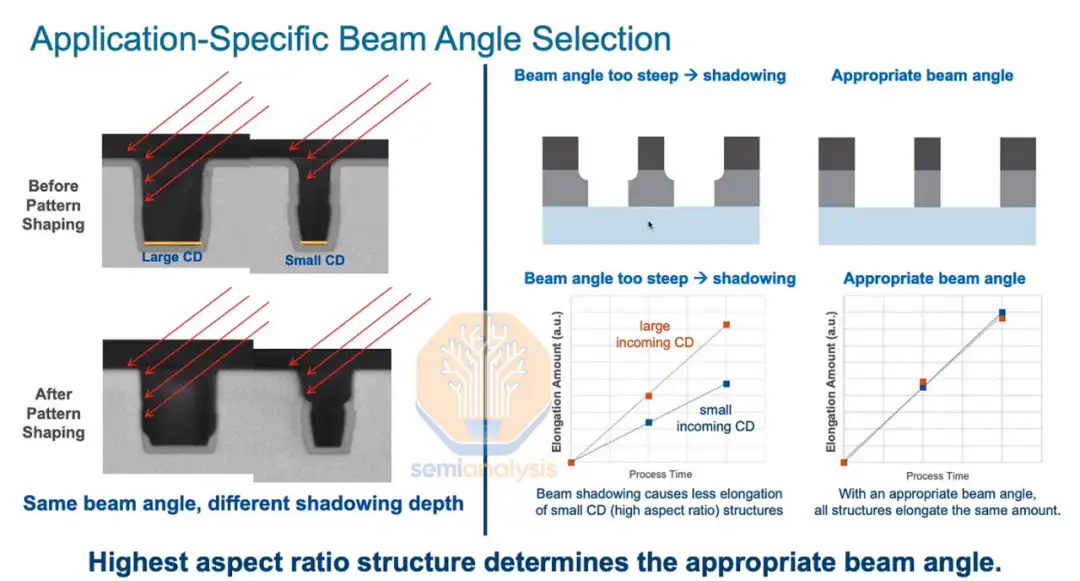
如果平坦化层和硬掩模具有不同的蚀刻选择性,则等离子束将导致侧壁不均匀平直。
必须优化特征的侧壁轮廓,否则会出现性能、功率或良率问题。
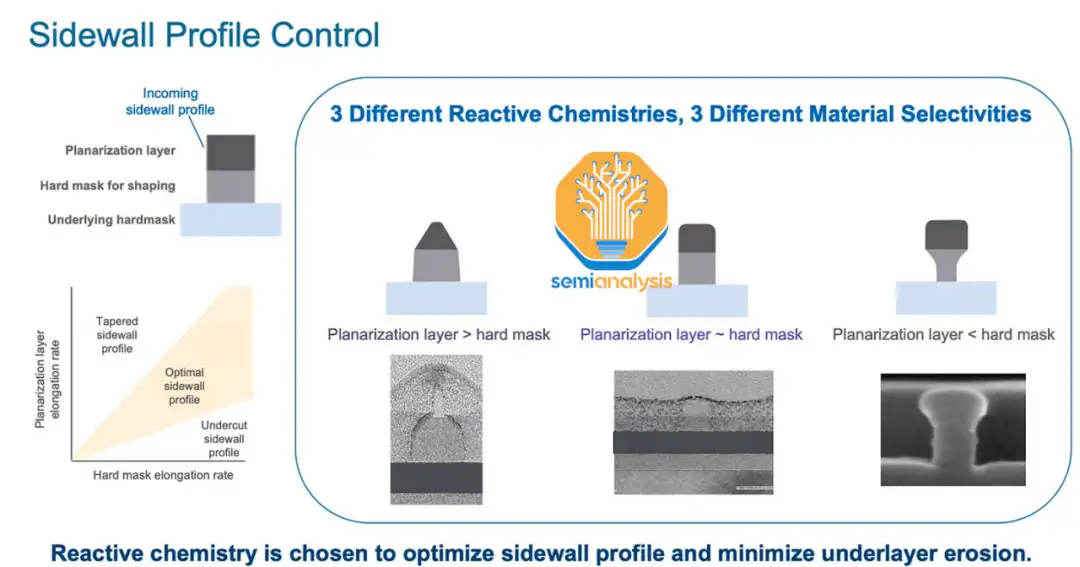
等离子束的角度对于晶圆厂进行优化以确保各种尺寸的特征具有均匀一致的伸长量非常重要。使用较高的角度与较低的角度将兼顾蚀刻所需的时间、顶层的侵蚀率和底层的侵蚀率等因素,以保持关键尺寸的完整性。每个应用程序将有不同的光束角度和时间。应用材料公司研究了多种不同的化学物质,因此光束可用于各种硬掩模、底层和中间层。

图案成形发生在光刻胶和抗反射涂层的显影、清洁和蚀刻之后。
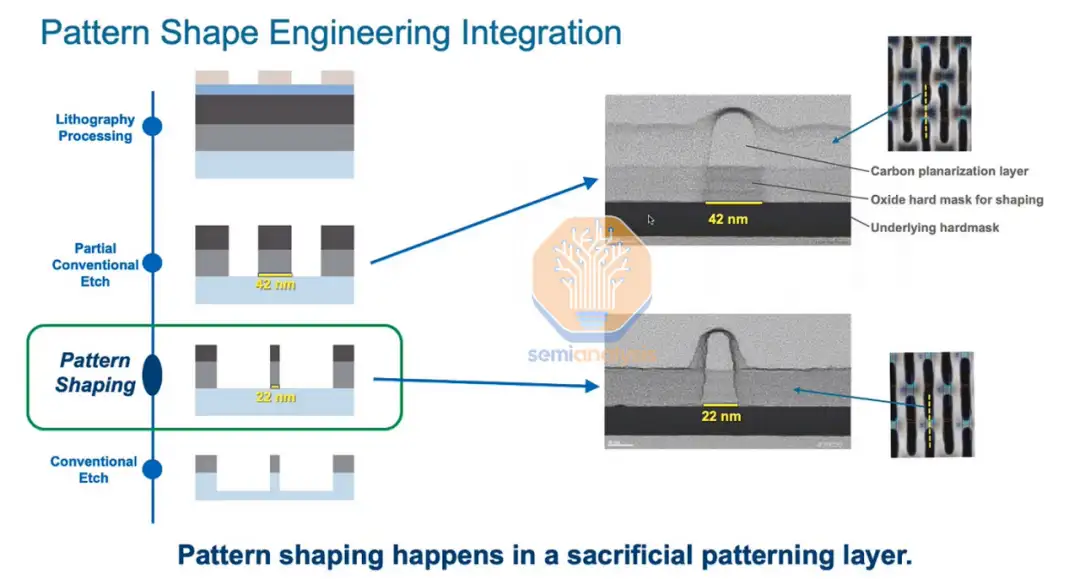
一旦发生图案成形,就可以进行图案转移蚀刻。即使你有多个掩模和图案化阶段,这也允许使用图案整形。图案整形可以与多重图案组合。
模式塑造不仅仅需要朝着现有特征的方向发展。它也可以在任何任意角度进行。对我们来说,这似乎更多地展示了 Applied 与 Sculpta 的对齐和过程控制,而不是非对称整形的实际用例。
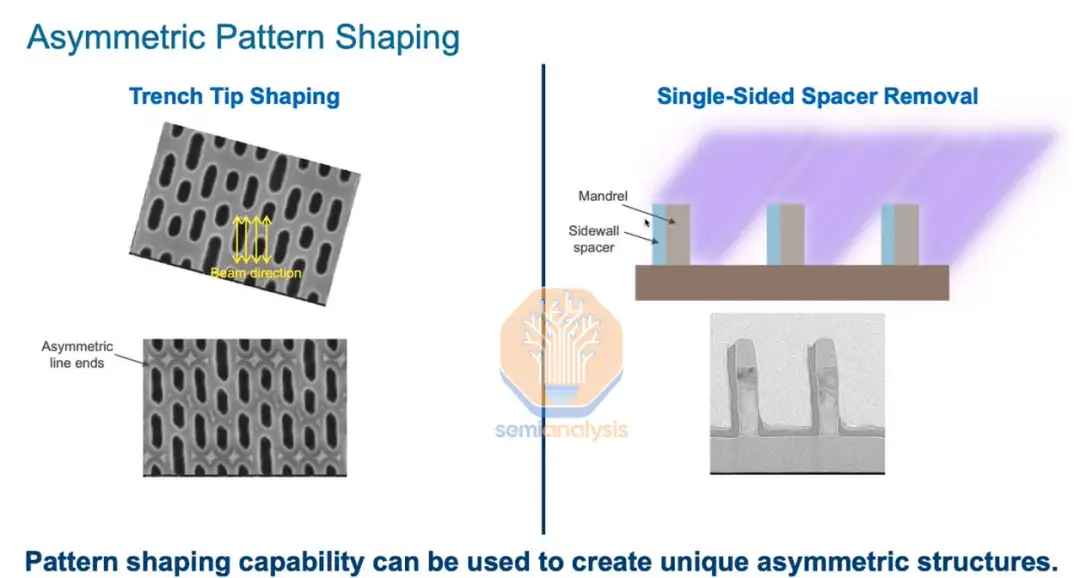
现在我们已经介绍了什么是模式塑造,是时候介绍模式塑造的实际用例了。
用例
Scuplta 工具有 3 个主要用例:紧密的孔和槽图案、更窄的尖端到尖端图案以及消除随机桥接。
第一个应用是使用传统的光刻 (LE) 方法获得具有紧密角对角尺寸的孔和槽图案,这需要多重图案化。借助图案整形,你的优势在于只需使用一个 LE 步骤即可从一个角落到另一个角落。紧密的角对角很重要,因为它可以让你将更多功能放入同一区域。在这种使用过孔的情况下,由于有更多的过孔区域,因此可以提高性能和功率特性。

在上图中,你可以在左侧看到如何使用传统的自对准 LELE 技术实现紧密的角对角。你需要 2 个不同的掩模来实现过孔的紧角对角,但是通过图案整形,你可以使用一个掩模来创建所有没有紧角到角的过孔,然后对过孔进行整形。
第二个应用是生产具有更紧密的尖端到尖端图案的沟槽。这与第一个应用程序非常相似,但具有不同的功能类型。在此应用中,图形整形用于在不使用第二个掩模的情况下使两组线尽可能靠近。

左边是传统的 LELE 技术。第一个蒙版创建线条,然后第二个蒙版在两者之间创建一个拆分,以获得尽可能紧密的尖端间距。通过图案塑造,你可以使用一个面具创建两组线条,中间有一条松散的沟槽。然后 Sculpta 可以去除尽可能多的材料,使沟槽尽可能薄。

第三个应用是减少随机桥接缺陷。随机桥接缺陷位于一条线上,其中蚀刻无法去除它应该具有的所有材料。一般来说,这是因为光刻胶层也没有正确曝光。





评论