AI热潮下,芯片制造商将芯片堆叠起来,就像搭积木
7月11日消息,人工智能热潮推动芯片制造商加速堆叠芯片设计,就像高科技的乐高积木一样。
本文引用地址:http://www.amcfsurvey.com/article/202307/448500.htm业内高管称,这种所谓的Chiplet(芯粒)技术可以更轻松地设计出更强大的芯片,它被认为是集成电路问世60多年以来最重要的突破之一。
IBM研究主管达里奥·吉尔(Darío Gil)在接受采访时表示:“封装和Chiplet技术是半导体的未来重要组成部分。”“相比于从零开始设计一款大型芯片,这种技术更加强大。”
去年,AMD、英特尔、微软、高通、三星电子和台积电等科技巨头组成了一个联盟,旨在制定Chiplet设计标准。英伟达,作为全球首个市值超过万亿美元的芯片公司,随后加入了该联盟。IBM和一些中国公司也是成员之一。
苹果去年推出高端Mac Studio电脑,并在今年6月进行了更新,是最早采用Chiplet技术连接两个计算处理器的消费产品之一,这些芯片由台积电生产。近几个月,英特尔和英伟达也分别宣布推出基于Chiplet技术的定制产品。
智能手机等典型消费设备包含各种类型的芯片,用于数据处理、图形处理、内存、通信和电源控制等功能。这些芯片通过微小的线路精细地连接,并封装在保护性塑料外壳中,形成可固定在电路板上的封装。
借助新的Chiplet封装技术,工程师们找到了将现有芯片组合在一起的方法,就像用几块乐高积木搭建玩具车一样简单。
一位业内人士将芯片设计师比作菜谱创作者,将Chiplet比作预先准备好的食材。他表示,芯片设计公司可以将他们想要的成分混合在一起,"然后简单地烹饪出菜品,马上端上餐桌"。
这个概念特别吸引人工智能公司,他们急于设计针对人工智能计算优化的芯片。
英伟达表示,其Chiplet技术可以将其现有产品(如图形处理芯片)与具有特殊需求公司设计的定制芯片连接在一起。
英伟达在去年提交的一份报告中表示,由于在狭小空间内封装更多晶体管变得越来越困难,芯片堆叠“将成为以低成本和低功耗方式继续提升芯片性能的主要机制”。
全球最大的芯片代工厂商台积电为苹果等客户提供了设计基于Chiplet的产品的平台。该公司预计,到2025年,其先进封装生产的厂房面积将是2021年的两倍。
各大公司仍在努力降低Chiplet的生产成本,并继续研究如何最有效地将Chiplet拼接在一起。此外,验证Chiplet性能需要不同的流程,并且并非适合所有功能。业内人士表示,Chiplet设计非常适合售价超过4000美元的高端苹果台式电脑等产品,而不适用于当前大众智能手机的主芯片。
然而,由于设计和制造最先进芯片的成本飙升,如果可能的话,使用Chiplet技术将几片不太先进的芯片组合起来以提高性能是有意义的。
半导体分析公司Real World Insights创始人大卫·坎特(David Kanter)表示:“先进封装技术成本更高……但随着新型芯片越来越贵,先进封装技术变得更具吸引力。”









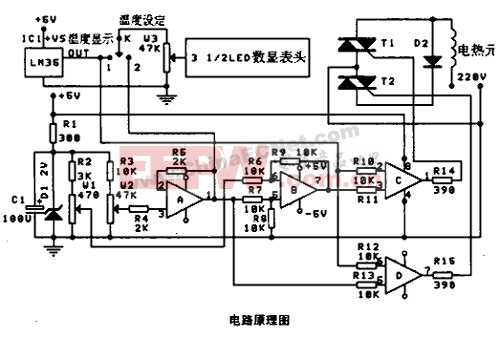
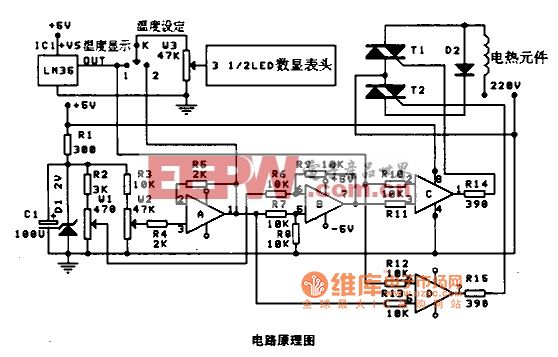

评论