失效分析系列之—热点定位
失效分析(Failure analysis)的作用是针对异常芯片(电性/可靠性测试异常)进行失效点定位,并结合芯片的原始设计情况判断芯片失效的机理。失效分析需要全面的知识,比如电子、工艺、结构、材料、理化等很多方面都会涉及到。失效定位在不破坏样品或者部分破坏样品的情况下,定位出失效问题的物理位置。
本文引用地址:http://www.amcfsurvey.com/article/202401/454559.htm热点定位的原理依据,激光作用于半导体材料时,会产生两种效应,一种是热效应(热辐射),另一种是光生载流子效应(光子辐射)。(1)如果激光波长的能量小于半导体能带,半导体仅仅发生热效应;(2)当大于或接近半导体能带时,会产生热和光生载流子,且载流子占主导作用。光子辐射和热辐射均能导致半导体电阻发生变化或者产生电流。
(1)OBIRCH(Optical Beam Induced Resistance Change)即光束诱导电阻变化,是先进制程里最有效的定位方法,通过用高度聚焦的激光扫描通过加电压芯片的表面,可以找到短路/漏电的故障点。高度聚焦的激光会在聚焦的区域内造成局部温度上升,从而造成电阻变化,最后导致外加电压或电流的变化。激光扫描的方法有两种激光波段1340nm和1064nm,可以适用于硅片和III-V族器件的正面和背面分析。
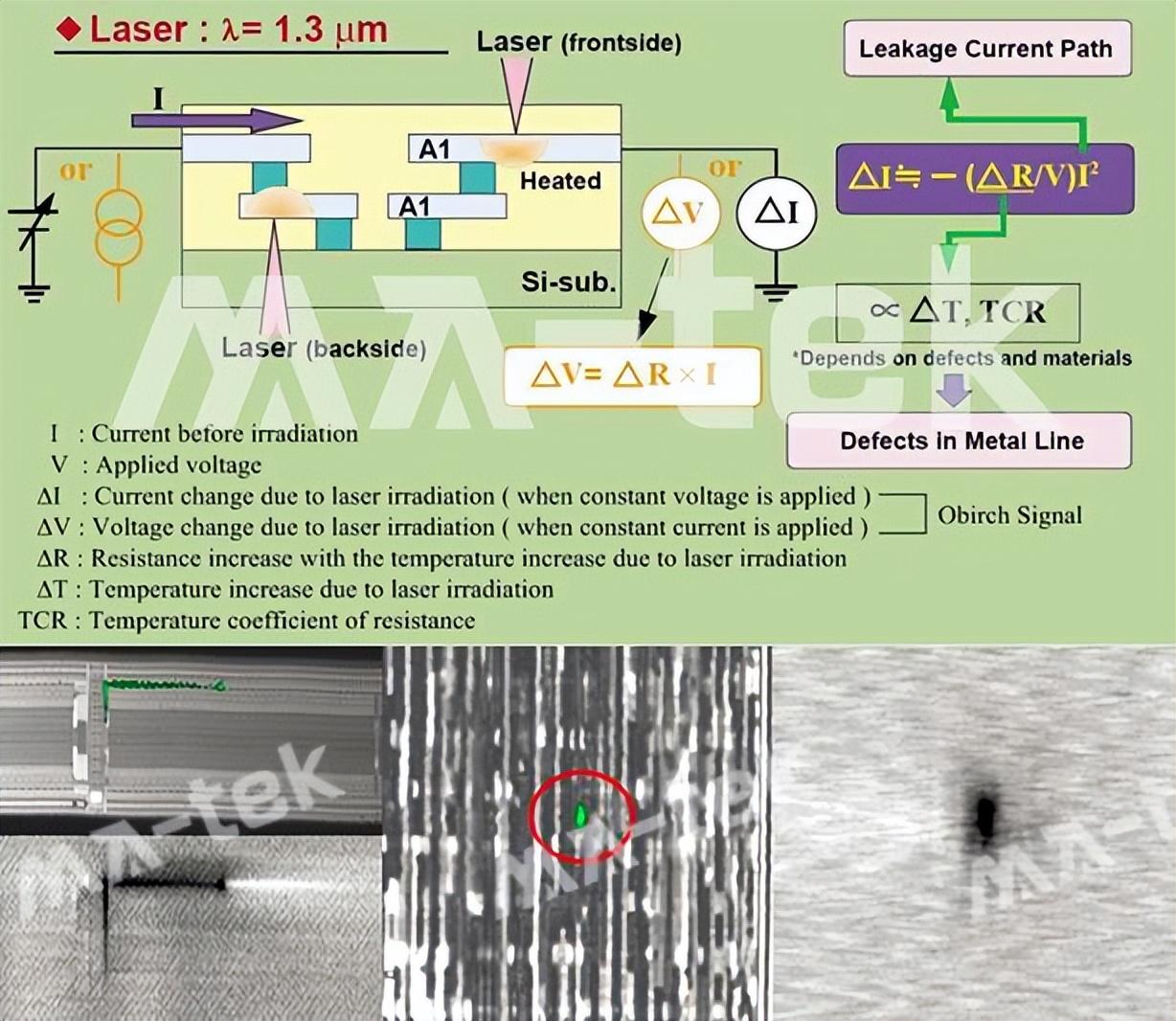
OBIRCH技术原理
OBIRCH正是基于半导体的热效应的新型高分辨率微观缺陷定位技术,该技术依托于背面光发射显微镜,可以在大范围内准确并迅速定位集成电路中的微小失效点,并通过后续的去层处理、电镜扫描和光学显微镜观察,对缺陷进行界定,找出失效机理并进行根因分析,因而在器件和集成电路失效分析中得到广泛应用。它具有迅速(只需通过一次成像就能检查复杂集成电路的发光)、通用(能与测试仪相连)、洁净(不需薄膜)、简单(与探针无相互作用,不会人为产生问题)、灵敏(漏电流可以小至uA量级)等优点。
OBIRCH能快速准确的进行IC中元件的短路、布线和通孔互联中的空洞、金属中的硅沉积等缺陷。其工作原理是利用激光束在恒定电压下的器件表面进行扫描,激光束部分能量转化为热能,如果金属互联线存在缺陷,缺陷处温度将无法迅速通过金属线传导散开,这将导致缺陷处温度累计升高,并进一步引起金属线电阻以及电流变化,通过变化区域与激光束扫描位置的对应,定位缺陷位置。OBIRCH模式具有高分辨能力,其测试精度可达nA级。
应用范围:
常用于芯片内部电阻异常及电路漏电路径分析。
1.可快速对电路中缺陷定位,金属线/Poly/Well短路(Metal Short/Metal Bridge)。
2.闸极氧化层漏电,金属导通孔/接触孔阻值异常任何有材质或厚度不一样的Short/Bridge/Leakage/High Resistance。
3.利用镭射激光穿透芯片背面晶背(Si或者GaAs)进行表面检查。
4.高级PCB上的金属走线失效缺陷的定位等的芯片失效情况。
此外还包括以下缺陷类型的定位:
IDDQ (Idd guiescent current)静态电流故障分析
侦测金属线内的缺陷(空洞,矽瘤Silicon Nodules)
侦测金属接触孔的阻值异常(via, contact的接触不良或漏电特性皆可侦测到)
Metal或poly的桥接
线路或元件的烧毁
闸极氧化层漏电
ESD/Latch-up故障分析
P-N接面漏电或崩溃
操作中的元件,如电晶体与二极体
IC上每个点被雷射照到,阻值与电流都会有变化,而缺陷位置,电流变化一般比其他位置更明显,影像中的点会变得更黑或更白,黑色和白色分别表示电流量减少与增加(即电阻的增加与减少),为了更明显区分,机台供应商把黑白两色设定为红绿两色。
红点:表示当Obirch laser加热物质时,电流变化量变大,即物质越加热阻值变得越低。
绿点:表示当Obirch laser加热物质时,电流变化量变小,即物质越加热阻值变得越高。
如果Obirch找到的异常点不明显,可以控制加大雷射的输出功率提升温度的变化量,或者提高输入电压增加电流。Obirch一般适用于DC静态失效分析,如果引起失效的缺陷不和电源或地相连,如signal,Obirch分析所加偏置不易激励失效线路。
(2)InGaAs EMMI: IC在通电的状态下,MOS器件发生介质击穿、热载流子注入、PN结反向漏电以及CMOS电路发生闩锁效应时,电子空穴对复合 (EHP-Electron Hole Pairs Recombination) 并放出光子。
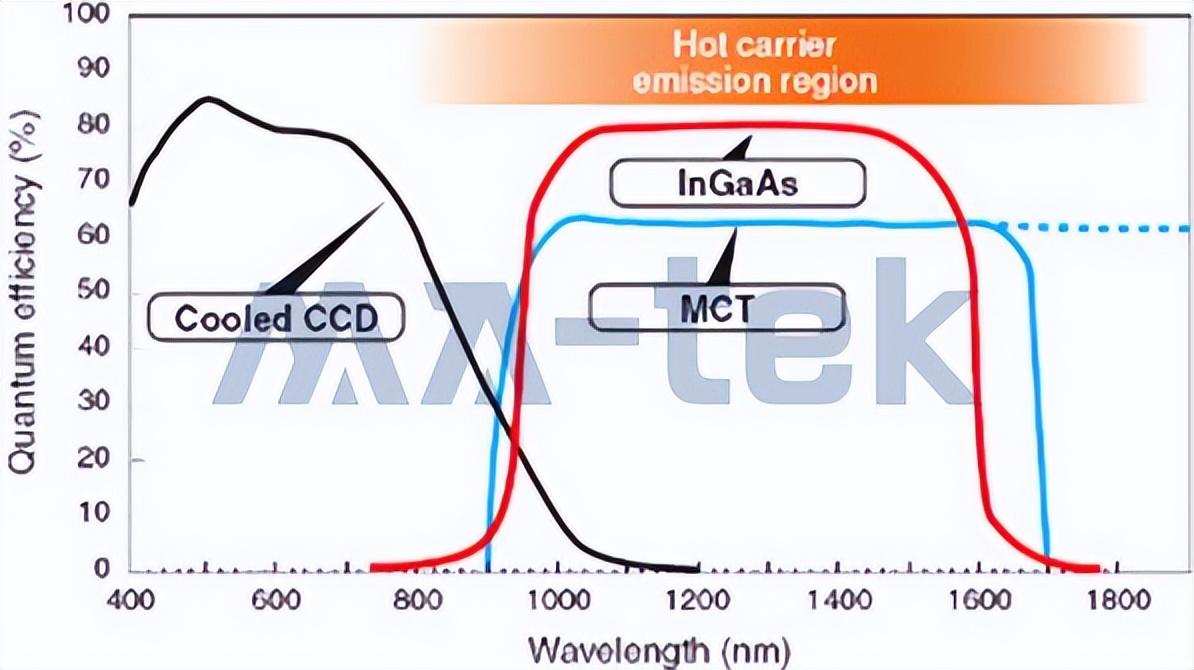
EMMI detector
故障处或者非故障处都有可能放出光子。这些光子流通过收集和光增益放大,再经过CCD光电转化和图像处理,得到一张发光图,将发光图和器件表面的光学发射像叠加,对失效点和缺陷进行定位。
欧姆特性短路、金属互连短路、表面反型层和扩散电阻等缺陷产生的光辐射波长不在可见光范畴或信号太弱,一般不适用于用EMMI来定位。
(3) Lock-in Thermal: 利用高灵敏度的InSb detector 侦测IC在通电状态下,缺陷位置产生出的热辐射分布,从而定位出失效所在位置。
如果为3D封装,异常位置在叠层die上,即使做backside处理,亮点也会被遮挡。Thermal EMMI可以利用失效点热辐射传导的相位差,预估3D封装的失效点深度(Z轴方向),定位是某一层die或者封装体本身出现异常。

深度预估

计算过程
此外,如果样品需要在EVB上调至某一工作状态才会出现漏电流的情况,因样品需焊接在EVB上,无法参考EMMI(InGaAs)和Obirch做backside处理,只能从正面开盖,实验中亮点很可能被metal层遮挡。针对IC动态工作状态下的异常问题,用Thermal EMMI分析也较为方便。



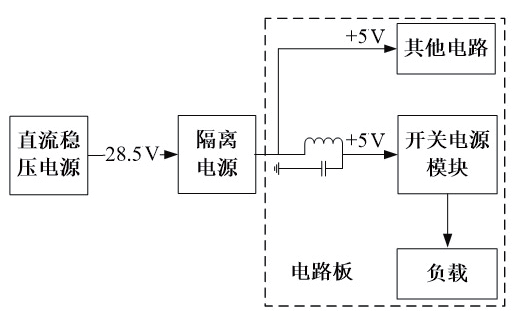



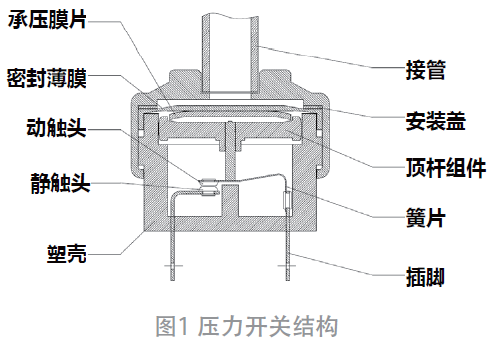

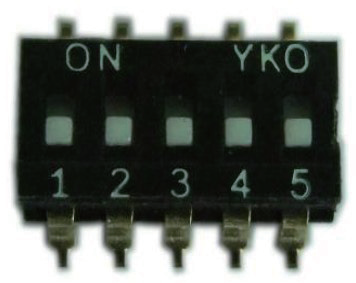


评论