大算力芯片,正在拥抱Chiplet
在和业内人士交流时,有人曾表示:「要么业界采用 Chiplet 技术,维持摩尔定律的影响继续前进,要么就面临商业市场的损失。」随着摩尔定律走到极限,Chiplet 被行业普遍认为是未来 5 年算力的主要提升技术。
本文引用地址:http://www.amcfsurvey.com/article/202404/457250.htm战场已拉开,纷争开始了
Chiplet 不算是新的技术,但是这股浪潮确实是近年来开始火热的。
什么是 Chiplet?
Chiplet 俗称芯粒,也叫小芯片,它是将一类满足特定功能的 die(裸片),通过 die-to-die 内部互联技术实现多个模块芯片与底层基础芯片封装在一起,形成一个系统芯片,以实现一种新形式的 IP 复用。
简单来说,可以理解为将每个小的芯片用「胶水」缝合在一起,形成一个性能更强的大芯片。这也不算是一个新鲜的技术,例如:英特尔将两个芯片(一个 CPU 和一个用于 CPU 大型 L2 高速缓存的快速静态内存芯片)放在一起,放入公司于 1995 年末推出的 Pentium Pro CPU 的封装中。
也许去年,大部分厂商还沉浸在 Chiplet 技术的未来应用上,那到了今天 Chiplet 已经成为各大厂商的产品中的必选角色。
首先来看 AMD,AMD 是选择 Chiplet 最积极的厂商之一。
在 2019 年的时候,AMD 就初次尝试了 Chiplet 封装,将不同工艺节点的 CPU 内核且 I/O 规格不同的芯片封装在一起,显著提高了能效和功能。
之后,AMD 又发布了实验性产品,即基于 3D Chiplet 技术的 3D V-Cache。使用的处理器芯片是 Ryzen 5000,采用台积电 3D Fabric 先进封装技术,成功地将包含有 64MB L3 Cache 的 Chiplet 以 3D 堆叠的形式与处理器封装在了一起。
从数据性能来看,采用 3D Chiplet 的原型芯片将性能平均提高了 12%。从这一点上,也能看到 3D Chiplet 对实际工作负载的提升有实质性的贡献。
不止在 CPU,AMD 在 GPU 方面也选择了 Chiplet 技术。目前,AMD 发布的最新 MI300 系列芯片时,同样采用 Chiplet 技术,8 个 GPU Chiplet 加 4 个 I/O 内存 Chiplet 的设计,总共 12 个 5nm Chiplet 封装在一起,使其集成的晶体管数量达到了 1530 亿,高于英伟达 H100 的 800 亿晶体管。这款芯片在推出时,也是打出了对标英伟达 H100 的口号。
此外,AMD 含 Chiplet 技术的 CPU 销量占比也在不断提高。根据德国电脑零售商 Mindfactory 数据,2021 年 10 月至 2022 年 12 月间 AMD CPU 的销量中,含 Chiplet 技术的 CPU 销量占比不断提高,从约 80% 上升至约 97%。
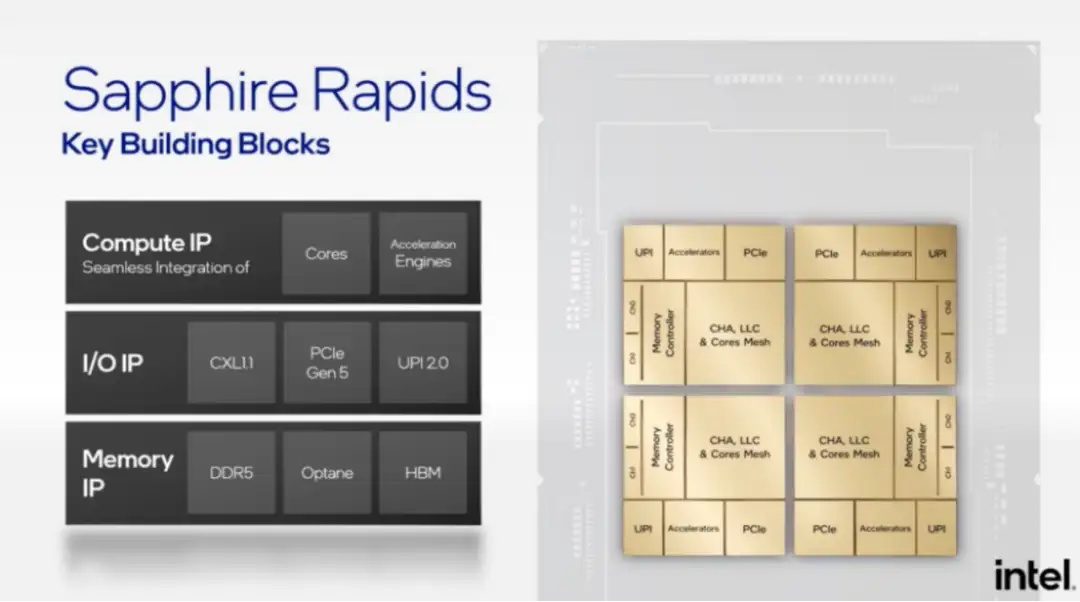
再来看英特尔。英特尔的首次推出基于 Chiplet 设计的处理器是 Sapphire Rapids,时间在 2023 年 1 月。
具体来看,通过两组镜像对称的相同架构的 building blocks,组合 4 个 Chiplets,获得 4 倍的性能和互联带宽。每个基本模块包含计算部分(CHA & LLC & Cores mesh,Accelerators)、memory interface 部分(controller,Ch0/1)、I/O 部分(UPI,PCIe)。通过将上述高性能组件组成基本的 building block,再通过 EMIB 技术进行 Chiplet 互联,可以获得线性性能提升和成本收益。
最后,来看英伟达。英伟达坐稳 GPU 领域霸主这一点毋庸置疑,而霸主英伟达在今年推出的「最强」GPU B200 也同样采用 Chiplet 技术。GB200 超级芯片是由 2 颗 B200 GPU 和 1 颗 Arm 架构的 Grace CPU(中央处理器)组合而来。
由此可见,英特尔、AMD、英伟达都在自家的 CPU、GPU 上使用了 Chiplet 技术。这将 Chiplet 推入了一个全新的商业化阶段。
Chiplet 这一锤,算是重重砸下了。
Chiplet 从 CPU 到 GPU
在之前传统的 GPU 也是由一个中央工作负载处理器,将渲染任务发送到芯片内的多个着色器块之一。每个单元都被赋予一块几何体来处理、转换为像素,然后对它们进行着色。
后来 AMD 发现,Chiplet 用在 CPU 上效果很好,并且降低了制造成本。于是在 GPU 上也选择了放弃中央处理器,用多个小芯片取代单个硅块,每个小芯片处理自己的任务。渲染指令以称为命令列表的长序列发送到 GPU,其中所有内容都称为绘制调用。
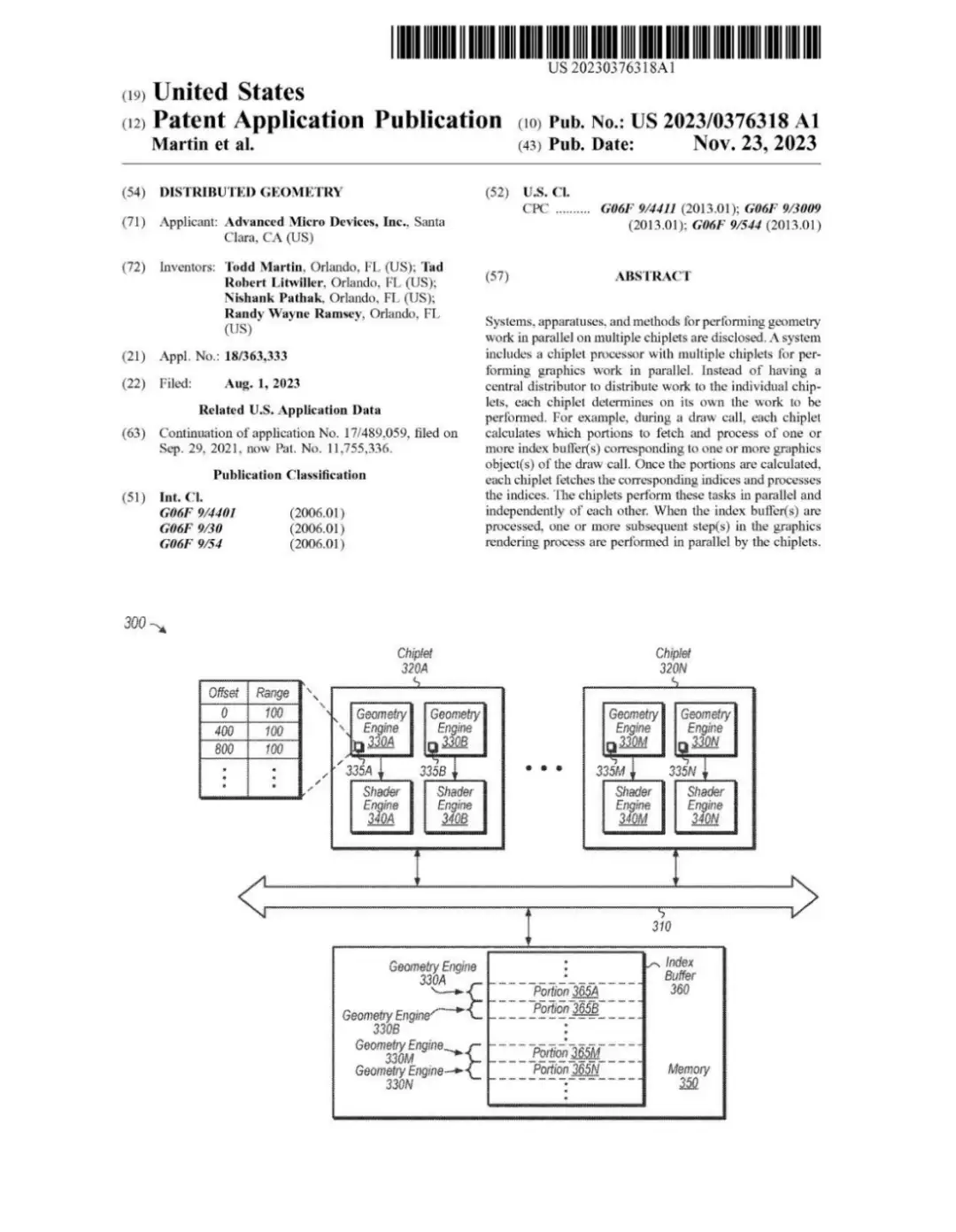
AMD 2019 年 Chiplet 专利
该文件于 2019 年 6 月发布,即提交近两年后,该功能已在 RDNA 2 中实现。AMD 于 2020 年开始推广该架构,并于同年 11 月推出了首款配备全新 RT-texture 处理器的产品。
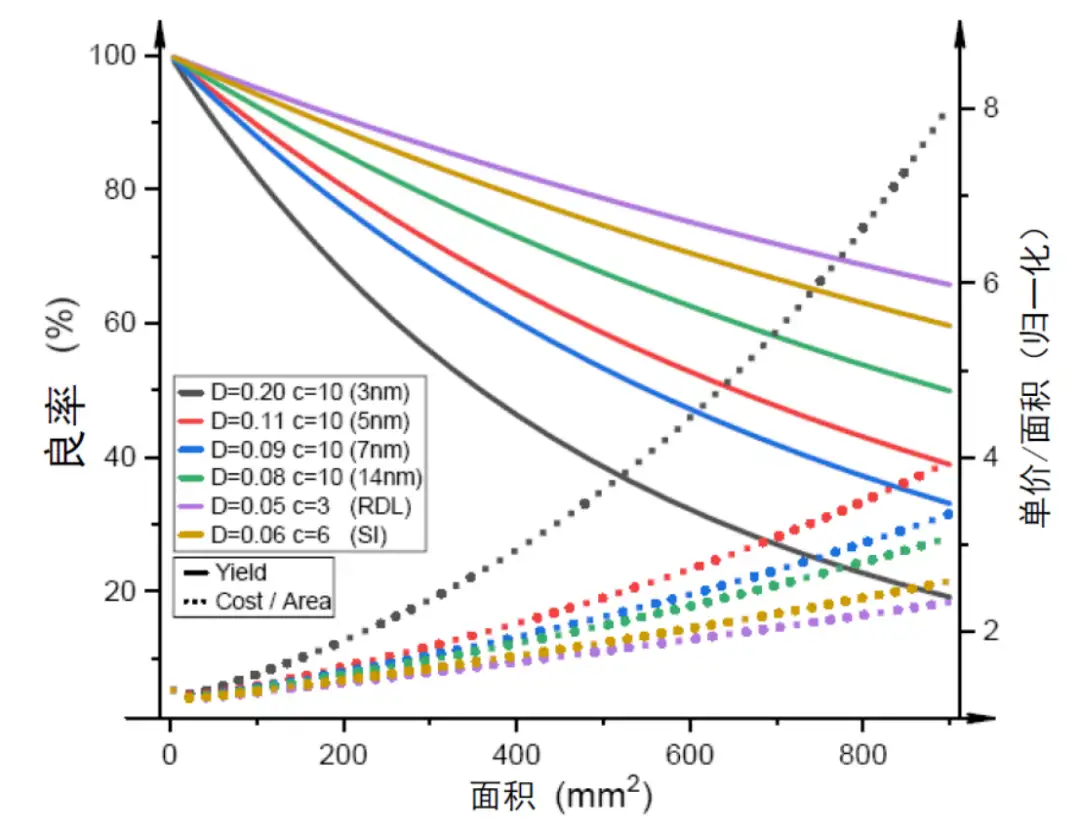
不同制程及封装技术下的芯片良率、成本、面积的关系 注:D 为缺陷密度,c 为负二项分布中的集群参数或 Seed』s model 中临界值数量
摩尔定律没死,但确实是老了,在 14nm 之后成本曲线就变了。5nm 工艺的成本相比 7nm 工艺增长了近 1 倍,3nm 工艺相比 5nm 工艺预计将增长近 1 倍。在半导体工艺、规模限制越来越大的情况下,传统大芯片的策略确实是寸步难行。
总体来看,Chiplet 有四大优点:
第一,通过将功能块划分为小芯片,那么不需要芯片尺寸的持续增加。这就提高了良率并简化了设计和验证的流程。
第二,每个小芯片是独立的,那就可以选择最佳工艺。逻辑部分可以采用尖端工艺制造,大容量 SRAM 可以使用 7nm 左右的工艺制造,I/O 和外围电路可以使用 12nm 或 28nm 左右的工艺制造,这就大大降低了制造的成本。
第三,组合多样,适合定制化,轻松制造衍生类型。比如说采用相同的逻辑电路但是不一样的外围电路,或相同外围电路但不同的逻辑电路。
第四,不同制造商的小芯片可以混合使用,而不仅仅是局限在单个制造商内。
这些特点都非常适合用在大算力芯片上。相较于传统消费级芯片,算力芯片面积更大,存储容量更大,对互连速度要求更高。采用 Chiplet 既可以降低成本提升良率,又可以允许更多计算核心的「堆料」,还能便于引入 HBM 存储。
越接近摩尔定律极限如 5nm、3nm 和 2nm 的芯片走 Chiplet 设计路线越有意义。
清华大学交叉信息研究院特聘研究员、助理教授马恺声也分析过,到底什么样的芯片适合使用 Chiplet:「具体到芯片应用来说,CPU 和 GPU 这种大芯片是适合的,对于大芯片来说,建议是超过 200 平方毫米,最好是超过 400 平方毫米的是适合做 Chiplet 的;如果仅从成本角度看,如 MCU 这样本身价格较低的芯片目前是没有必要的。」
我们也能看到,Chiplet 技术在 CPU 和 GPU 上的商用确实比较顺利。
Chiplet 时代,代工厂偷偷赚大钱
Chiplet 制造步骤相对于封装复杂度大幅提升,同时考虑到不同的连接方式对于精度的要求和工艺要求不同,制造过程分布在 IDM、晶圆厂和封装厂。
这给台积电、英特尔带来了商机。

3nm 制程技术占据了台积电晶圆总收入的 6%,5nm 和 7nm 分别占晶圆总收入 33% 和 19%。先进制程(7nm 及以下)占台积电晶圆总收入的比重达到了 58%。
前文提到的 AMD 发布的 3D V-Cache 实验性产品背后,是台积电的先进半导体工艺技术和先进封装技术。台积电作为同时掌握了最先进半导体工艺和封装技术的代工厂,其全球最顶尖代工厂的地位得到了巩固,同时其在先进技术领域也将变得更加强势。
那么台积电的 7m、5nm 可以得到更好地利用。如果仔细来看台积电的营收,在先进制程方面的收入使得其业绩一路高升。
不过,对于台积电来说,Chiplet 也带来了新的挑战。通过采用 Chiplet,台积电避免了传统的垄断模式,使客户理论上能够从多个来源获得其芯片。这增加了客户的选择自由度,促使了更加竞争激烈的市场环境。
不同于 AMD 和英伟达,英特尔一直在发展其 IDM 2.0 的战略,将晶圆代工看得非常重要。
从代工这方面来看,Chiplet 对于英特尔也有不一样的影响。
一方面,英特尔承诺过的 4 年交付 5 个工艺节点(intel 7、intel 4、intel 3、intel 20A、intel 18A),如果使用 Chiplet,那么英特尔可以避免为复杂的 CPU 或 GPU 执行完整工艺所需的困难。
另一方面,英特尔还可以利用混合制造厂商(使用来自多个代工厂的 Chiplet 并将其打包)的概念来获得代工厂商机。在去年,英特尔宣布与台积电携手打造全球首款符合 Chiplet 互连产业联盟(UCIe)标准的多芯片封装芯片,当中包含英特尔与台积电各自生产的 IC。
值得注意的是,英特尔是第一个主动选择,多源代工业务模式的厂商。
结语
Chiplet 的探索正在围绕着 CPU 和 GPU 这两大领域,但从长远来看,随着 Chiplet 产业链更加成熟,Chiplet 的发展将不局限于这类大芯片,而是会有更广阔的运用空间。
Chiplet 的风行,也让半导体产业必须有所调整,以建构出对应的完善生态系统。目前市场上的 Chiplet 产品,是各家大厂自行发展出来的成果,故目前半导体业内存在多种不相通的 Chiplet 互连技术,导致 Chiplet 生态系呈现碎片化的局面。
目前在底层封装层面,已经有台积电、英特尔等厂商提供 CoWOS、EMIB 等先进封装,可以提供超高速、超高密度和超低延时的 Chiplet 互联;在标准协议层面,也有众多大厂领衔发布的 UCIe 1.0 版本,提供了跨片接口设计的指导和约束。
Chiplet 的春风在吹了。




评论