国产光刻胶新突破!
近日,华中科技大学与湖北九峰山实验室的研究团队在光刻胶技术领域取得重大进展,成功突破“双非离子型光酸协同增强响应的化学放大光刻胶”技术。
本文引用地址:http://www.amcfsurvey.com/article/202404/457281.htm在半导体制造环节,光刻胶是不可或缺的材料,其质量和性能是影响集成电路电性、成品率及可靠性的关键因素。但光刻胶技术门槛高,市场上制程稳定性高、工艺宽容度大、普适性强的光刻胶产品屈指可数。当半导体制造节点进入到100nm甚至是10nm以下,如何产生分辨率高且截面形貌优良、线边缘粗糙度低的光刻图形,成为光刻制造的共性难题。
为此,华中科技大学与九峰山实验室联合研究团队通过巧妙的化学结构设计,以两种光敏单元构建“双非离子型光酸协同增强响应的化学放大光刻胶”,最终得到光刻图像形貌与线边缘粗糙度优良、space图案宽度值正态分布标准差(SD)极小(约为0.05)、性能优于大多数商用光刻胶。且光刻显影各步骤所需时间完全符合半导体量产制造中对吞吐量和生产效率的需求。
依托九峰山实验室工艺平台,该自主研发的光刻胶体系已完成产线初步工艺验证,并同步完成了各项技术指标检测优化,成功打通从技术研发到产业转化的全流程。该研究成果有望为光刻制造的共性难题提供明确的方向,同时为EUV光刻胶的着力开发做技术储备。






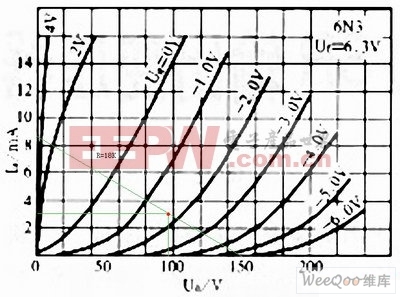

评论