分享:探索白光LED劣化原因
最近几年全球各国对环保、省能源等能源议题越来越关心,因此间接牵动这些领域的投资与技术开发,在这之中又以太阳电池、锂离子电池、SiC功率晶体管、白光LED最受注目,一般认为上述计划在国家规模的支持下,今后可望成为高度成长的领域。
本文引用地址:http://www.amcfsurvey.com/article/168189.htm白光LED已经从移动电话、液晶电视背光模块,正式跨足进入医疗、汽车、植物栽培等一般应用照明领域,国外业者甚至推出平价60W等级的白光LED灯泡,这类使用复数个白光LED的新世代照明光源,正快速取代传统荧光灯与白热灯泡。
有关液晶电视背光模块或是大型照明,使用数量众多的白光LED,必须同时兼具成本与性能的传统课题,日本业者普遍认为2011年可望实现0.5日圆/lm、200lm/W的预定目标,其中芯片性能的提升、荧光体、封装技术的开发,一直扮演关键性的角色。可靠性是白光LED另外一项重要课题,它包含单体LED的耐久性,以及复数白光LED同时点灯时的辉度分布等等,为克服这些问题,国内外厂商已经积极展开技术开发。
有关白光LED的耐久性亦即LED的劣化,一般认为光束、封装,以及芯片的时间性劣化,是造成寿命降低的主要原因,然而实际上这些劣化要因错综复杂,因此劣化模式的分析非常困难,特别是白光LED的寿命很长,不易进行劣化试验。传统劣化试验例如:电流加速试验、温度加速试验、加速耐候试验等等,接着本文要介绍“过电压劣化试验”的结果,以及白光LED劣化的分析结果。
分析方法与评鉴项目
图1是典型照明用白光LED的基本结构与劣化要因一览;表1是GaN系LED与相关材料主要评鉴项目,以及分析手法一览。穿插式电子显微镜(TEM;Transmission Electron Microscope) 可以根据LED的断面结构直接观察转位与缺陷,劣化分析时微细部位的歪斜、应力、成分、载子浓度、缺陷评鉴非常重要,特别是奈米等级的载子浓度与缺陷评鉴分析,一般都使用:扫描型探针显微镜(SPM;Scanning Probe Microscope)、扫描型扩散阻抗显微镜(SSRM;Scanning Spread Resistance Microscopy)、扫描型容量显微镜(SCM;Scanning Capacitance Microscopy)、阴极发光法 (CL;Cathodo Luminescence)。


有关树脂与荧光体结构的评鉴,一般认为使用:傅立叶红外分光法(FT-IR;Fourier Transform Infrared Spectrometer)、固体核磁共鸣法(固体NMR;Solid-State Nuclear Magnetic Resonance)、拉曼 (Raman) 分光法可以获得预期效果。
芯片劣化的评鉴
有关GaN系组件的问题点,由于它的缺陷密度比GaAs系高5位数,而且缺陷与转位问题非常严重,一般认为LED芯片的缺陷与转位,对LED的劣化、耐久性等特性具有直接、重大的影响。传统在蓝宝石基板上长膜的GaN单结晶膜,由于蓝宝石基板与GaN的格子定数差异极大,因此强大的压缩应力对GaN膜层有相关性,这也是形成缺陷与转位主要原因。最近业者大多改用格子定相近的SiC单结晶晶圆,或是格子定数相同的GaN单结晶晶圆长膜,制作低缺陷、低转位高质量的GaN磊晶(Epitaxial)。
获得白色光源的方法有两种,分别是蓝光LED与黄色荧光体组合的拟似白光方式,以及高演色白光方式。拟似白光方式,主要是蓝光LED组合黄色荧光体,构成拟似白光的LED,蓝光LED芯片产生的蓝光一旦被黄色荧光体吸收,荧光体会产生黄光,该光线再与未被黄色荧光体吸收的蓝光混合,形成所谓的拟似白光,该白光LED的发光频谱具有白光与蓝光二种峰值。
高演色白光方式,主要是蓝光LED组合绿色与红色荧光体,形成高演色白光LED,蓝光LED产生的蓝光一旦被荧光体吸收,绿色荧光体会产生绿色光线,红色荧光体则产生红色光线,该绿色光线再与红色光线,以及未被荧光体吸收的蓝光混合形成拟似白光,该白光LED的发光频谱具有红、蓝、绿三种领域的峰值,色再现性也比上述拟似白光方式优秀。
拟似白光方式使用的典型蓝光LED断面结构如图2所示,发光层是由膜厚100nm以下GaN系化合物半导体量子井构成,发光时会形成缺陷与转位,它也是LED劣化原因之一。

图3是在蓝宝石基板上制作GaN单结晶薄膜时,面内CL强度分布范例,由图可知分别在360nm与560nm附近,可以发现GaN能隙之间的发光,与造成缺陷的「黄色瑕疵」发光光线。图3(a)是GaN单结晶薄膜利用平面扫描型电子显微镜(SEM;Scanning Electron Microscope)观察时的影像;图3(b)是360nm附近光线的强度分布;图3(c)是发光线的强、弱部位的CL频谱分布特性。图3(b)是发光强度降低的暗带,特别是在360nm附近,能隙之间的发光强度会降低,此时若与能隙之间的发光比较,560nm附近的黄色瑕疵发光强度反而会变强。

根据以上结果证实在黑点明亮部位结晶性会降低,其结果造成无辐射迁移的机率增加,能隙端的发光强度则明显降低。
图4是从断面方向测试时,CL强度分布的加速电压相关性,图中可以观察到贯穿膜厚方向明暗的纹缟模样,由此可知电压加速降低时纹缟模样鲜明,而且还可以获得高空间分辨率的强度分布。
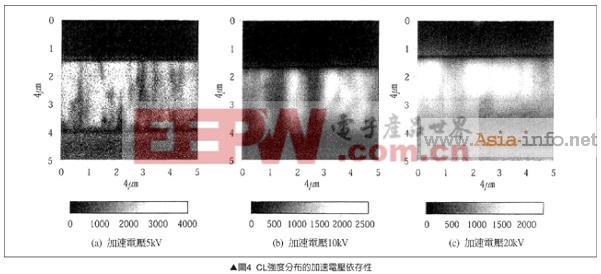
贯穿膜厚方向CL强度明暗纹缟模样,与图5穿插式电子显微镜(TEM)观察到的贯穿转位周期一致,反过来说上述图3单结晶面内,观察到的300nm周期的纹缟模样,正反映此贯穿转位周期,由此证实使用阴极发光法 (CL),能够以奈米等级清楚观察到缺陷与转位的分布。

图6是上述图2蓝光LED施加电压劣化时,使用扫描型扩散阻抗显微镜测试该LED断面的结果。扫描型扩散阻抗显微镜是以接触型原子间力显微镜(AFM;Atomic Force Microscope) 为基础,再利用导电性探针与大范围放大电路构成。扫描型扩散阻抗显微镜利用接触试料表面模式的原子间力显微镜回馈,强化旋臂探针触压(加大负荷)的扫描分析手法,由于它使用高导电性探针,检测施加至试料时偏压电压在接触位置形成的微电流,因此可以正确掌握试料表面局部性阻抗分布。

根据图6扫描型扩散阻抗显微镜的测试结果,证实劣化LED的p型clad层内,V型凹孔的高低阻抗领域有增加趋势,由于V型凹孔是在InGaN量子井结构内发现的特征性缺陷,因此又称作“V型瑕疵”,由图6(a)、(b)的比较可知,施加过电压时V型瑕疵会增加。
图7是利用阴极发光法(CL)测试蓝宝石基板上已掺杂硅的GaN薄膜结果,阴极发光法主要是观察量子井(以下简称为活性层),以及蓝宝石基板与clad层之间缓冲层造成的波长为463nm、360nm附近的光线。463nm活性层造成的发光光线强度分布如图7(a)、(b)所示,图7(a)、(b)同时也是未通电与劣化组件的CL强度分布特性;图7(c)是未通电与劣化组件的CL频谱特性。












评论