存储器大厂:HBM4,2025年供货!
人工智能浪潮之下,HBM从幕后走向台前,市场需求持续看涨。全球市场研究机构TrendForce集邦咨询预测,2023年HBM需求量将年增58%,2024年有望再成长约30%。
本文引用地址:http://www.amcfsurvey.com/article/202310/451432.htm与传统DRAM相比,HBM具备高带宽、高容量、低延时与低功耗等优势,可以加快AI数据处理速度,更适用于ChatGPT等高性能计算场景,因而备受青睐,存储大厂也在积极推动HBM技术迭代。
存储大厂持续发力,三星将推出HBM4
自2014年首款硅通孔HBM产品问世至今,HBM技术已经更新迭代出多款产品,分别有HBM、HBM2、HBM2E、HBM3、HBM3e等。
原厂规划方面,此前集邦咨询调查显示,两大韩厂SK海力士(SK hynix)、三星(Samsung)先从HBM3开发,代表产品为NVIDIA H100/H800以及AMD的MI300系列,两大韩厂预计于2024年第一季送样HBM3e;美系原厂美光(Micron)则选择跳过HBM3,直接开发HBM3e。
HBM3e将由24Gb mono die堆栈,在8层(8Hi)的基础下,单颗HBM3e容量将一口气提升至24GB,此将导入在2025年NVIDIA推出的GB100上,故三大原厂预计要在2024年第一季推出HBM3e样品,以期在明年下半年进入量产。
除了HBM3、HBM3e之外,最新消息显示,存储大厂还在规划推出下一代HBM——HBM4。
近日,三星电子副社长、DRAM产品与技术团队负责人黄尚俊对外表示,三星电子已开发出9.8Gbps的HBM3E,计划开始向客户提供样品。同时,三星正在开发HBM4,目标2025年供货。据悉,三星电子正开发针对高温热特性优化的非导电粘合膜(NCF)组装技与混合键合(HCB)等技术,以应用于HBM4产品。
9月韩媒报道表示,为了掌握快速成长的HBM市场,三星将大幅革新新一代产品制程技术,并推出HBM4产品。据悉,HBM4内存堆栈将采用2048位内存接口 。此前所有HBM堆栈都采用1024位接口。接口宽度从每堆栈1024位增加到每堆栈2048位,足以可见HBM4具备的变革意义。
HBM4为时尚早,明年市场主流还得看HBM3与HBM3e
尽管HBM4将有大突破,但它毕竟不会很快到来,谈应用以及普及为时尚早。业界指出,当前HBM市场以HBM2e为主,未来HBM3与HBM3e将挑起大梁。
集邦咨询调查显示,当前HBM市场主流为HBM2e,包含NVIDIA A100/A800、AMD MI200以及多数CSPs自研加速芯片皆以此规格设计。同时,为顺应AI加速器芯片需求演进,各原厂计划于2024年推出新产品HBM3e,预期HBM3与HBM3e将成为明年市场主流。
以HBM不同世代需求比重而言,据TrendForce集邦咨询表示,2023年主流需求自HBM2e转往HBM3,需求比重分别预估约是50%及39%。随着使用HBM3的加速芯片陆续放量,2024年市场需求将大幅转往HBM3,而2024年将直接超越HBM2e,比重预估达60%,且受惠于其更高的平均销售单价(ASP),将带动明年HBM营收显著成长。








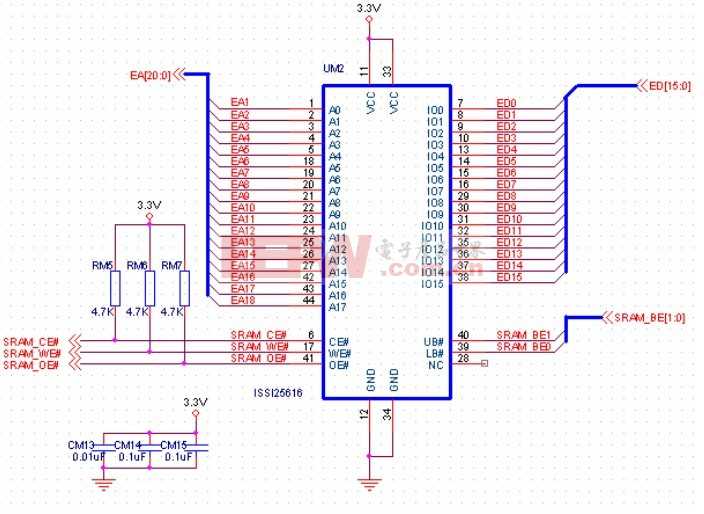


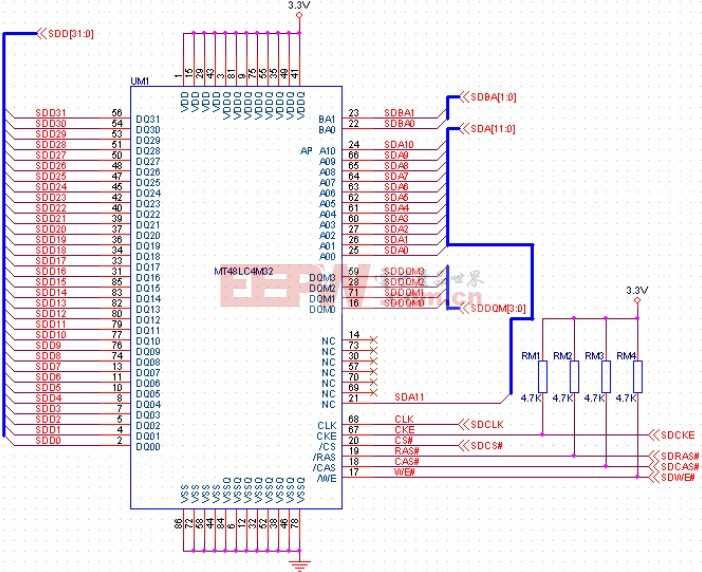


评论