光刻行业遭双重打击 下一代技术面临难题
——
半导体光刻工艺面临技术和成本压力
光刻行业正遭到双重打击:对用于集成电路生产的远紫外光刻技术而言,机会窗口在慢慢关闭;而最有希望的一项替代技术即193纳米沉浸式光刻技术却成本高昂,于是行业陷入一片混乱当中。成本增加会对芯片尺寸的继续缩小带来严重的影响。
在近期国际光学工程学会(SPIE)主办的先进光刻技术大会上,种种不利迹象表明,一再推迟的远紫外光刻技术可能会进一步推迟到2013年,用于16纳米节点——如果该技术果真能实现的话。这可能会妨碍像英特尔和三星这些站在前沿的芯片生产商,它们曾希望有机会获得远紫外光刻工具,用于2011年22纳米节点的早期开发阶段。
远紫外光刻技术存在的问题为一批新兴技术提供了契机,譬如沉浸式光刻、无掩膜光刻和纳米压印光刻。但至少就32纳米和22纳米节点而言,领先的竞争技术还是193纳米沉浸式光刻,这项光刻技术涉及“两次曝光(doub
le exposure)”和“两次图形曝光(double patterning)”这两个热门术语。
虽然许多公司已经证明了两次曝光和两次图形曝光切实可行,但沉浸式光刻技术的成本高于如今的图形曝光方法。这意味着,芯片制造成本将来可能会大幅提升。这会对将来继续竭力为每个工艺技术节点降低集成电路的比特价格带来不利影响。
在SPIE先进光刻技术大会上,应用材料公司、海力士、IBM和比利时校际微电子研究中心(IMEC)各自介绍了有望降低这项技术成本的方法。
分析师G. Dan Hutcheson是VLSI研究公司的首席执行官,他认为如果业界不去寻找新的光刻解决方案,摩尔定律就会失效。
Hutcheson仍认为,远紫外光刻技术有一席之地。他说:“远紫外光刻技术大有前途,但可能是在22纳米之后的某个时候。远紫外光刻技术会出现在16纳米阶段。”Hutcheson对无掩膜光刻和纳米压印光刻较为悲观。他说:“除了研究领域外,无掩膜光刻不可能取得成功。纳米压印光刻技术也在半导体行业没有用武之地。”
这样一来,193纳米沉浸式光刻技术成了近期的选择。
IBM公司最近宣布,它并没有指望将远紫外光刻技术用于逻辑芯片的22纳米节点的早期开发阶段——之前这家公司还对此寄予希望——远紫外光刻技术的前景显得更黯淡了。IBM及合作伙伴声称,它们会把193纳米沉浸式光刻技术向下扩展到22纳米节点,这要归功于两次图形曝光或者两次曝光技术。
IBM杰出工程师、光刻技术开发部门主管George Gomba在SPIE技术大会上做报告时说:“用于22纳米节点早期开发的远紫外光刻技术将会推迟。沉浸式光刻技术将是惟一能够满足22纳米节点的两年周期和需求的解决方案。”
远紫外光刻技术的主要支持者英特尔公司同意IBM的评价。英特尔高级研究员、技术和生产部的先进光刻部门主管Yan Borodovsky说:“我们会有一样的看法。”他说,远紫外光刻技术仍存在一直以来阻碍开发的“同一些问题”,包括缺少光掩膜、功率源和光刻胶(resist)。另外,每台光刻机的售价可能高达惊人的7000万美元。
圆晶代工巨头台积电公司的微制像技术发展处资深处长林本坚在SPIE大会上说:“人家说魔鬼在于细节;我要说,魔鬼在于掩膜、功率源和成本。”
英特尔的Borodovsky说,接下来的12到18个月对实现远紫外光刻技术至关重要。不过他坚持认为,这项技术仍在英特尔的路线图上,用于2011年的22纳米节点。
实际上,远紫外光刻技术在英特尔内部已经推迟了几次。英特尔曾想利用远紫外光刻技术用于32纳米节点。但去年,英特尔推迟了将这项技术投入32纳米生产的工作。
大相径庭的技术
远紫外光刻技术使用13.5纳米波长,与如今使用的传统光刻工具大相径庭。工艺步骤在多反射镜真空室里面进行。光学元件基本上是没有缺陷的反射镜,这些反射镜通过层间干扰来反射光线。
将远紫外光刻技术投入市场方面的进展很缓慢。譬如说,为了获得每小时生产100块圆晶的产能,远紫外光刻工具要有可以生成100瓦持续功率的功率源。迄今为止,最好的功率源在猝发模式下也只能生成四分之一的持续功率。
最近,光刻设备巨头ASML控股公司为比利时勒芬的IMEC芯片生产研究组织和总部设在纽约的奥尔巴尼纳米技术研究中心交付了远紫外光刻“演示型”工具。ASML现正在开发一种更先进的“预生产型”远紫外光刻设备,定于2009年下半年批量生产。上周,ASML声称它在这个方面取得了突破,它可以使用该工具刻印32纳米密集线路和接触孔。
ASML公司的营销副总裁Peter Jenkins说:“这是难度很大的技术。我们认为,能够显示低于30纳米的图案这项功能极具意义。”
不甘落后的竞争对手尼康公司在上周披露了远紫外光刻技术路线图,声称它会在年底之前交付两款原型,并在2009年年底之前推出一款生产型设备。
在幕后,ASML、佳能和尼康彼此竞相开发新的193纳米沉浸式扫描光刻设备,这种设备用于两次曝光和两次图形曝光时代。首款这种设备定于2008年年中前后推出。
两次曝光的优点
几家芯片生产商已经将两次图形曝光技术运用到集成电路生产,据说美光科技公司也在此列。两次图形曝光要求进行两次曝光,首先曝光一半线路、进行蚀刻、执行其他步骤。然后,另一光刻胶涂层做到圆晶上,另一半图案在第一批线路之间的空隙里面曝光。这种方法成本高、速度慢,但从技术上来说相对容易,不过要求大约2纳米的套刻精度(overlay accuracy)。
于两次曝光,它需要先曝光一批线路,然后在执行其他工艺步骤之前,将曝光图案移到邻近地方,对第二批线路进行曝光。虽然两次曝光
速度比两次图形曝光快,但关键是找到一种非线性光刻胶——这种光刻胶的化学特性能够吸收来自邻近曝光的弱光,又不会形成图案。
至于逻辑芯片的生产,IBM上周提议后段制程采用基于暗场、双极照明的两次曝光技术。双极照明可以把掩膜图案分为X轴和Y轴两层,然后对它们进行两次曝光。
IBM在实验室里面使用了数值孔径为0.93的193纳米沉浸式扫描设备。IBM使用ASML的Maskweaver光学邻近校正工具和专门的三层光刻胶,声称已演示了第一层金属线之间的间距为90到100纳米的器件。
IMEC已开发出一种两次图形曝光技术,能够获得50纳米半间距、单镶嵌设计。IMEC使用了数值孔径为0.85的193纳米沉浸式扫描设备。它还采用与双极照明相竞争的四极照明方案,使用了6%的软相移掩膜(PSM)和有机材料的双层光刻胶。
应用材料公司在技术大会上演示了一种类似方法:自对准两次图形曝光技术,该技术面向干式光刻而不是沉浸式光刻,从而引起了人们的浓厚兴趣。该方法采用了应用材料公司的先进图膜(Advanced Patterning Film)和等离子增强的化学气相沉积系统。应用材料公司薄膜事业部的高级副总裁兼总经理Farhad Moghadam说:“该方法能够使用193纳米‘干式’扫描设备获得32纳米线路和间隙壁。”





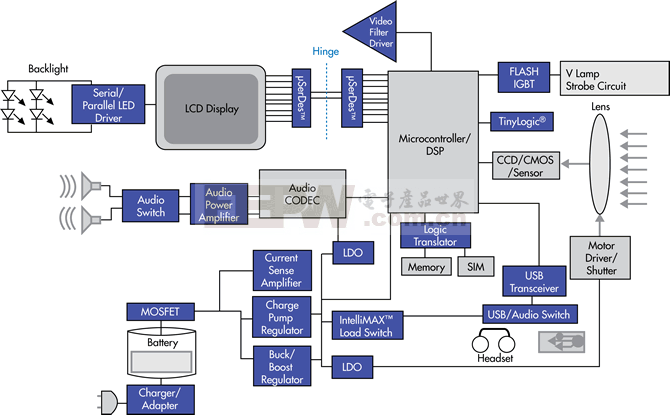








评论